Mikä on HDI PCB-levyjen laminointirakenne?
Sisällysluettelo
HDI PCB laminointi rakenne
Älypuhelimista on tulossa yhä ohuempia ja älykelloista yhä tehokkaampia. HDI (High-Density Interconnect) Piirilevytekniikka on tämän suuntauksen ytimessä. Perinteisiin piirilevyihin verrattuna HDI-laminointirakenne mahdollistaa monimutkaisempien piirien sijoittamisen pienempään tilaan.
Topfast on 17 vuoden kokemuksella toimiva piirilevyvalmistaja, joka on nähnyt lukuisten projektien epäonnistuvan sopimattomien HDI-laminointirakenteiden valinnan vuoksi, mikä on johtanut kustannusten ylittymiseen tai suorituskyvyn heikkenemiseen. Siksi on ratkaisevan tärkeää ymmärtää HDI-piirilevyjen erilaiset laminointirakenteet.

1. HDI PCB laminoinnin perusteet
HDI-levyjen ydin on tiheän reitityksen saavuttaminen seuraavilla tavoilla rakentamisprosessit, jotka eroavat olennaisesti perinteisestä PCB-valmistuksesta. Perinteiset piirilevyt ovat kuin voileipiä - kaikki kerrokset laminoidaan kerralla - kun taas HDI-levyt muistuttavat pilvenpiirtäjien rakentamista, mikä edellyttää kerroksittaista rakentamista.
Keskeiset prosessivertailut:
- Laserporaus: Luo halkaisijaltaan jopa 0,05 mm:n mikroläpivientejä (ihmisen hius ≈ 0,07 mm).
- Pulssi pinnoitus: Varmistaa tasaisen kuparin paksuuden mikroviasissa (<10% vaihtelu).
- Peräkkäinen laminointi: Tyypilliset parametrit - 170 °C ± 2 °C, paine 25 kg/cm², kerros kerrokselta kerrostuminen.
Eräässä älykelloprojektissa, jonka parissa työskentelin, siirtyminen perinteisestä 6-kerroksisesta piirilevystä (5 cm²) HDI-rakenteeseen (1 + 4 + 1) pienensi levyn koon 1,5 cm²:iin ja lisäsi samalla sykkeen seurannan - mikä osoittaa HDI:n taikuuden.
2. Yksityiskohtainen analyysi HDI-laminointirakenteiden päävirran rakenteista
1. Yksinkertainen yksittäinen laminointi (1+N+1)
Tyypillinen esimerkki: (1+4+1) 6-kerroksinen levy
Ominaisuudet:
- Sisäkerroksissa ei ole upotettuja läpivientejä, yksi laminointi.
- Sokeat läpiviennit, jotka on muodostettu laserporaamalla uloimmat kerrokset.
- Kustannustehokkain HDI-ratkaisu
Sovellukset:
- Alkutason älypuhelimet
- IoT-päätelaitteet
- Tilaa rajoittava kulutuselektroniikka
Tapaustutkimus: Bluetooth-kuulokemerkin hyväksymä (1+4+1) muotoilu, joka yhdistää Bluetooth 5.0:n, kosketusohjauksen ja akun hallinnan 8 mm:n halkaisijan tilaan.
2. Standardi yhden laminoinnin HDI (upotetuilla läpivienneillä)
Tyypillinen esimerkki: (1+4+1) 6-kerroslevy (upotetut läpiviennit L2-5:ssä)
Ominaisuudet:
- Sisäkerroksiin haudatut läpiviennit vaativat kaksi laminaattia.
- Yhdistää sokeat ja upotetut läpiviennit
- Kustannusten ja suorituskyvyn tasapaino
Suunnittelun sudenkuoppa: Virheellinen piilotettujen läpivientien sijoittelu aiheutti 15%:n impedanssipoikkeaman eräässä projektissa, mikä vaati uudelleensuunnittelua.
3. Standardi kaksinkertainen laminointi HDI
Tyypillinen esimerkki: (1+1+4+1+1+1) 8-kerroksinen levy.
Prosessin ominaisuudet:
- Kolme laminointivaihetta (ydin + ensimmäinen kerros + toinen kerros).
- Mahdollistaa monimutkaiset liitosarkkitehtuurit
- Tukee 3-vaiheisia sokeita läpivientejä
Suorituskyvyn edut:
- Soveltuu yli GHz:n nopeille signaaleille
- Parempi tehon eheys (omat tehokerrokset)
- 30% parannettu lämpötehokkuus
4. Optimoitu kaksinkertainen laminointirakenne
Innovatiivinen suunnittelu: (1 + 1 + 4 + 1 + 1 + 1) 8-kerroksinen levy.
Tärkeimmät parannukset:
- Siirretään upotettuja läpivientejä L3-6:sta L2-7:ään.
- Poistaa yhden laminointivaiheen
- 15% kustannusten alentaminen
Testitiedot: Tätä rakennetta käyttävä 5G-moduuli:
- 0,3dB/cm lisäyshäviö @10GHz
- 12% alhaisemmat valmistuskustannukset kuin perinteiset rakenteet
- 8% suurempi tuotto

3. Kehittyneet HDI-laminointirakenteiden mallit
1. Skip-Via suunnittelu
Tekniset haasteet:
- Sokeat läpiviennit L1:stä L3:een, L2:n ohi.
- 100% suurempi laserporaussyvyys
- Huomattavasti kovempi pinnoitus
Ratkaisut:
- Yhdistetty UV+CO₂ laserporaus
- Erityiset pinnoituslisäaineet syviä läpivientejä varten
- Parannettu optinen kohdistus (tarkkuus <25μm)
Opittu läksy: Eräs lennokin lennonohjauserä epäonnistui, koska siinä oli skip-via-pinnoitusongelmia, mikä aiheutti $50k:n uudelleenkäsittelykustannukset.
2. Pinottu Via-suunnittelu
Ominaisuudet:
- Sokeat läpiviennit, jotka on pinottu suoraan upotettujen läpivientien päälle.
- Lyhyemmät vertikaaliset liitännät
- Vähennetyt signaalin heijastuspisteet
Suunnittelun perusteet:
- Tiukka kerrosten kohdistuksen valvonta (<25μm virhe)
- Hartsitulppaus ilmataskujen estämiseksi
- Lisälämpökuormitustestaus (260 °C, 10 s, 5 sykliä).
4. HDI-laminointirakenteen valinta
1. Keskeiset valintatekijät
| Harkinta | Yksinkertainen yksittäinen laminointi | Monimutkainen kaksinkertainen laminointi |
|---|---|---|
| Kustannukset | $ | $$$ |
| Reititystiheys | Medium | Erittäin korkea |
| Signaalin eheys | Sopiva <1GHz | Sopii >5 GHz |
| Kehitysaika | 2-3 viikkoa | 4-6 viikkoa |
| Tuottoaste | >90% | 80-85% |
2. Toimialakohtaiset suositukset
Viihde-elektroniikka:
- Suositeltava: (1+4+1)
- Jälki/Tila: 3/3mil
- Blind via: 0.1mm
Autoteollisuuden elektroniikka:
- Suositellaan: (1+1+4+1+1+1)
- Materiaali: TG≥170°C
- Lisälämpöläpiviennit
Lääkinnälliset laitteet:
- Korkeimmat luotettavuusvaatimukset
- Vähän tyhjää hartsia sisältävä tulppaus
- 100% mikroleikkaustarkastus
5. Käytännön HDI-suunnittelutekniikat
1. Optimointiperiaatteiden kautta
- ≤3 Läpiviennit nopeissa signaalireiteissä
- Vierekkäisten läpivientien väli ≥5× läpivientien halkaisija
- Kaksinkertaiset läpiviennit
2. Stack-Up kultaiset säännöt
- Maatasojen vieressä olevat signaalikerrokset
- Suurnopeussignaalien reititys sisäisesti (vähentää säteilyä)
- Tiivis teho-maadoituskytkentä
3. Luotettavuuden parantaminen
- Lisää 0,1 mm:n lämpöeristettyjä läpivientirakenteita
- Kriittisten signaalien maasuojat
- 0,5 mm:n reitittömyysvyöhyke levyn reunoilla
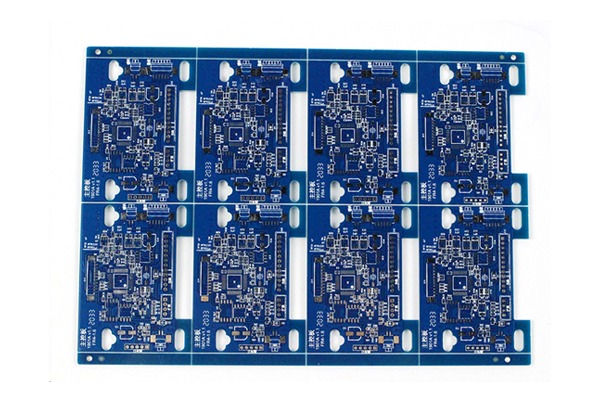
6. Tulevaisuuden suuntaukset
Kehittyvät teknologiat:
- Modifioitu puoli-lisäysprosessi (mSAP): 20/20μm jälki/avaruus.
- Matalalämpötilakeramiikka (LTCC): Erittäin korkea taajuus
- Sulautetut komponentit: Vastukset/ kondensaattorit levyjen sisällä
Materiaaliset läpimurrot:
- Modifioitu polyimidi: Dk=3,0, Df=0,002.
- Nanohopea johtava liima: Vaihtoehto pinnoitukselle
- Terminen grafeeni: 5× parempi lämmönjohtokyky
Eräässä laboratoriossa onnistuttiin prototyypittämään 16-kerroksinen 3D-interconnect HDI (1 mm paksu, 1024 kanavaa), mikä ennakoi entistä kompaktimpia tulevia laitteita.
Topfast Suositukset
Sopivaa HDI-laminaattirakennetta valittaessa on löydettävä optimaalinen tasapaino johdotustiheyden, signaalin eheyden, valmistuskustannusten ja luotettavuuden välillä. Yksinkertaisin rakenne tarjoaa usein suurimman tuottoprosentin ja alhaisimmat kustannukset.






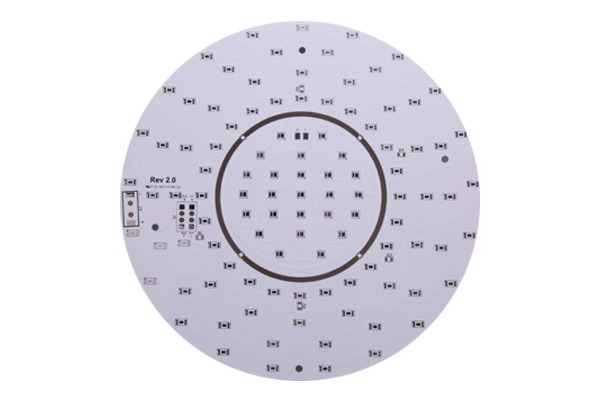



Aiheeseen liittyvät viestit