Siden introduktionen i 1980'erne er BGA-pakken (Ball Grid Array) hurtigt blevet den foretrukne pakkeform til integrerede kredsløb med høj densitet på grund af den høje pin-tæthed, fremragende elektriske og termiske ydeevne og pålidelighed. BGA-teknologien har udviklet sig fra de tidlige standard-BGA'er med 1,27 mm pitch til nutidens wafer-level chip scale packages (WLCSP) med 0,4 mm eller endnu finere pitch og fortsætter med at drive miniaturiseringen og den høje ydeevne af elektroniske enheder.
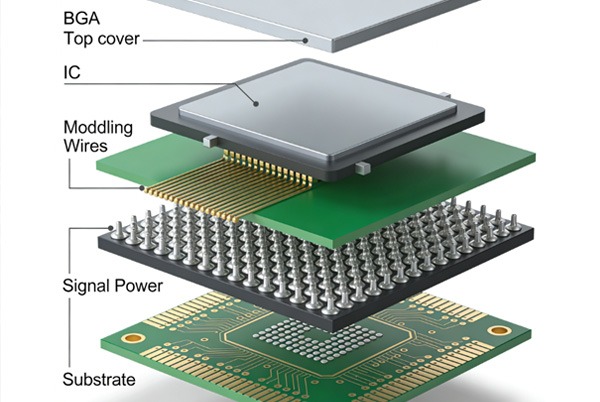
Indholdsfortegnelse
Aktuelle designudfordringer
- Stigende pin-tæthed: Moderne processorer har ofte mere end 1000 stifter, hvor afstanden er komprimeret til under 0,5 mm.
- Krav til signalintegritet: Højhastighedsgrænseflader (PCIe, DDR) stiller strenge krav til impedansstyring og undertrykkelse af krydstale.
- Kompleksitet i varmestyring: Øget effekttæthed forværrer risikoen for lokal overophedning.
- Grænser for fremstillingsprocessen: Traditionelle PCB-processer står over for udfordringer som mikrovias, via-fyldning og justeringsnøjagtighed.
BGA-pad-layout: Fra teoretisk beregning til teknisk implementering
2.1 Videnskabelig beregning af pad-størrelse
Forholdet mellem paddiameteren (d) og loddekuglens diameter (dball) er ikke et fast forhold, men bør baseres på loddemængden:

Hvor?
- (k): Befugtningskoefficient (typisk 0,8-0,9)
- (proces): Kompensation for produktionstolerance (typisk 0,05-0,1 mm)
TOPFAST Praktisk erfaring: Til en 0,5 mm pitch BGA anbefaler vi:
- Paddiameter på 0,25-0,28 mm for en loddekuglediameter på 0,3 mm.
- Ved hjælp af NSMD-design (Non-Solder Mask Defined) med loddemaskeåbning 0,05-0,1 mm større end pad'en.
- Tilføjelse af silketryksmarkeringer i A1-identifikationsområdet for at gøre det lettere at justere samlingen.
2.2 Pitch-design og planlægning af flugtveje
Kapaciteten for flugtrutning afgør, om BGA-designet kan lade sig gøre. Antallet af routingkanaler (Nflugt) kan estimeres ved:

Hvor?
- (p): Boldhøjde
- (w): Sporets bredde
- (s): Sporafstand
Allokeringsstrategi med flere lag:
| BGA-rækker | Minimum signal-lag | Anbefalet lagfordeling |
|---|---|---|
| ≤5 rækker | 2 lag | Øverste lag + indre lag 1 |
| 6-8 rækker | 3-4 lag | Øverste lag + 2-3 indre lag |
| ≥9 rækker | 5+ lag | Kræver HDI eller nedgravede vias |
Termiske aflastningspuder: Finjusteret balance i varmestyring
3.1 Termodynamiske principper og parameteroptimering
Termiske aflastningspuder regulerer varmestrømmen ved at kontrollere kobberforbindelsens tværsnitsareal. Deres termiske modstandsmodel er:

Hvor?
- (n): Antal eger (typisk 2-4)
- (w): Egerbredde (0,15-0,25 mm)
- (t): Tykkelse af kobber
- (L): Termisk sti-længde
Retningslinjer for optimering:
- Strømstifter: 4 eger, bredde 0,2-0,25 mm
- Jordstifter: 2-4 variable eger, justeres ud fra behov for varmeafledning
- Signalstifter: Typisk direkte tilslutning, medmindre der er særlige termiske krav
3.2 Validering af TOPFAST-produktion
Test med termisk billeddannelse afslører:
- Temperaturforskelle ved hjørnepuder kan nå 15-20 °C, hvilket kræver særlig forstærkning i det termiske design.
- Loddeudbyttet falder med 8-12%, når egerbredden er <0,15 mm.
- Det anbefales at tilføje termisk aflastning omkring strøm/jord-pads; brug direkte forbindelse til signal-pads.

Escape Routing: Fra traditionel dog-bone til avanceret via-in-pad
4.1 Grænser og optimering af Dog-Bone Fanout
Traditionelt dog-bone-layout er velegnet til BGA-pitches ≥0,8 mm. Dens kernebegrænsning er:

Hvor (c) er minimumsafstanden (typisk 0,1 mm).
Optimeringsteknikker:
- Brug ovale puder til at forlænge forbindelseshalsen.
- Kontrol via diameter mellem 0,2-0,25 mm.
- Brug forskudt routing på de indre lag for at forbedre kanaludnyttelsen.
4.2 Via-in-Pad-teknologi
Når pitch ≤0,65 mm, bliver via-in-pad en nødvendig teknologi. TOPFAST tilbyder to typer løsninger:
Type VII Microvia (IPC-4761 Standard):
- Laserboret, diameter 0,1-0,15 mm
- Harpiksfyldt + planarisering af kobberhætte
- Understøtter den blinde via-struktur, hvilket reducerer interferens mellem lagene
Overvejelser om design:
- Pad-kompensation: Det område, som via'en optager, skal være inden for 20% af paddiameteren.
- Behandling af loddemaske: Brug loddemaskeplugging eller fyldplanarisering.
- Afvejning af omkostninger: Microvias øger omkostningerne med 15-25%, men forbedrer routing-tætheden med 2-3 gange.
Co-design af flerlagsstackup og signalintegritet
5.1 Stakning Arkitektur Planlægning
Empirisk sammenhæng mellem antallet af BGA-pins (Nstifter) og det nødvendige antal lag (Nlag):

Eksempel på konfiguration af 8-lags kort:
| Lag | Funktion | Tykkelse | Noter |
|---|---|---|---|
| L1 | Signal + Pads | 0,1 mm | Rute de yderste 2 rækker |
| L2 | Jordplan | 0,2 mm | Fast plan |
| L3/4 | Signal-lag | 0,15 mm | Rute række 3-6 |
| L5/6 | Kraftfulde fly | 0,2 mm | Opdelte planer |
| L7 | Signallag | 0,15 mm | Rute de resterende rækker |
| L8 | Signal + Pads | 0,1 mm | Komponenter på undersiden |
5.2 Impedans-kontrol og undertrykkelse af krydstale
Vigtige foranstaltninger:
- Differentielle par: Tæt koblet routing, længdematchning ≤5 mils.
- Referenceplaner: Sørg for, at signallagene støder op til faste planer.
- Via tilbage-boring: For signaler >5GHz, fjern stub-effekter.
- TOPFAST særlig proces: Tilbyder lokal justering af dielektrisk tykkelse for at opfylde impedansnøjagtighed på ±7%.
Validering af produktionsprocesser og pålidelighed
6.1 DFM Tjekliste
- Tolerance for padstørrelse: ±0,02 mm (Laser Direct Imaging)
- Justering af loddemaske: ±0,05 mm (bekræft med producenten)
- Udskrivning af loddepasta: Stencilåbning 0,05-0,1 mm mindre end pude
- Røntgeninspektion: Tomrumshastighed <25% (IPC-A-610 Standard)
6.2 Elementer til pålidelighedstest
TOPFAST anbefalede en tre-trins verifikationsproces:
- Fase 1 Verifikation: Mikrosektionsanalyse (via kobbertykkelse, fyldkvalitet)
- Fase 2 Verifikation: Termisk cyklisk test (-55°C~125°C, 500 cyklusser)
- Fase 3 Verifikation: Test af forbindelsesmodstand (daisy chain-overvågning)
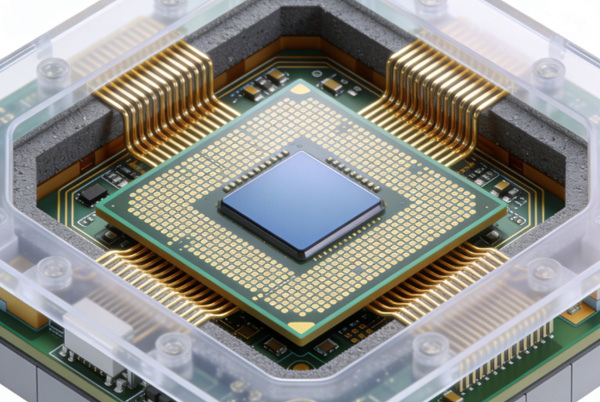
Fremtidige tendenser: Heterogen integration og avanceret indpakning
Med udviklingen af Chiplet- og 3D-IC-teknologier udvikler BGA-emballage sig i retning af:
- Silikone interposer BGA: Understøtter multichip-integration, hvilket forbedrer forbindelsestætheden med 10 gange.
- Indlejret substrat BGA: Passiver indlejret, hvilket reducerer området med 30-40%.
- Optoelektronisk integreret BGA: Understøtter optiske kanaler og bryder elektriske grænser.
Konklusion
Et vellykket BGA-design kræver, at man bevæger sig i fire dimensioner:
- Elektrisk dimension: Co-optimering af signal-/strømintegritet.
- Termisk dimension: Balance mellem varmeaflastningspuder og den samlede varmeafledning.
- Mekanisk dimension: CTE-matchning og afstresning.
- Produktionens dimension: Optimal proceskapacitet og omkostninger.
Baseret på erfaringer fra tusindvis af BGA-projekter opsummerer TOPFAST en firetrinsmetode: "Design - Simulering - Prototype - Masseproduktion", som hjælper kunderne med at opnå udbytter på 90% eller højere i deres første designforsøg. Husk på det: Den fineste BGA er ikke et teknologisk pragteksemplar, men det præcise skæringspunkt mellem systemkrav, designinnovation og produktionskapacitet.
5 almindelige spørgsmål og svar om PCB-design af BGA-pakker
A: Kerneprincip:
Padstørrelse = loddekuglens diameter × 0,85 ± proceskompensation
TOPFAST Anbefalede værdier:
0,5 mm pitch: Pad-diameter 0,3-0,35 mm
0,8 mm pitch: Pad-diameter 0,4-0,45 mm
1,0 mm pitch: Pad-diameter 0,5-0,55 mm
Vigtige overvejelser:
Brug NSMD-design (loddemaskeåbning 0,05 mm større end pad)
Skal bekræfte processens nøjagtighed med producenten
Tydelig markering af A1-positionen er afgørende
A: Obligatorisk brug:
Tilslutning til store kobberplaner for strøm/jord
Stifter med høj strømstyrke (>1A)
BGA-hjørnepositioner
Valgfri anvendelse:
Signalstifter bruger typisk en direkte forbindelse
Strømstifter med lav strømstyrke
TOPFAST anbefalede parametre:
Antal eger: 4
Egerbredde: 0,15-0,25 mm
Åbningsdiameter: 0,3-0,5 mm
A: Formel til estimering af antal lag:
Lag ≈ (antal ben, der kræver routing) ÷ (4 × rækker med routing pr. lag) + 1 lags margin
TOPFAST-routing-strategi:
Yderste lag: Rute de yderste 1-2 rækker
Indvendige lag: Brug dog-bone eller via-in-pad
Nøgle: Planlæg via lokationer tidligt
Anbefalinger fra Pitch:
≥0,8 mm: Fanout med hundeben
0,65-0,8 mm: Delvis via-in-pad
≤0,5 mm: Fuld via-in-pad
A: Fire vigtige punkter:
Kontrol af impedans: Gradvis tilspidsning fra pad til trace
Undertrykkelse af krydstale: Højhastigheds-signalafstand ≥ 3× sporbredde
Returvej: Sørg for jordforbindelse for hvert signal via
Strømintegritet: Placer afkoblingskondensatorer inden for 50 mils fra BGA.
TOPFAST tjekliste:
Matchning af differentielle pars længde ≤ 5 mils
Impedansstyring inden for ±7%
Kritisk netværkscrosstalk < -40dB
A: Designfasen:
Pad-overfladefinish: ENIG (højhastighedssignaler) eller ImAg (omkostningsfølsomme)
Stencil-design: Åbningsstørrelse 85-90% af pad-område
Kontrol af afstand: Sørg for, at minimumskravene til pudeafstand er opfyldt
Produktionsfase:
Inspektion af loddepastatryk
Røntgeninspektion (hulrumshastighed < 25%)
Verifikation af reflow-temperaturprofil
Test af elektrisk ydeevne
TOPFAST-erfaring:
Inddragelse af producenten i tidlige DFM-gennemgange kan reducere masseproduktionsproblemer med over 70%. Ved at give BGA-specifikationer til TOPFAST kan man få tilpassede procesanbefalinger.