Sedan introduktionen på 1980-talet har BGA-paketet (Ball Grid Array) snabbt blivit den föredragna förpackningsformen för högdensitetsintegrerade kretsar tack vare sin höga stifttäthet, utmärkta elektriska och termiska prestanda samt tillförlitlighet. BGA-tekniken har utvecklats från tidiga standard-BGA:er med 1,27 mm pitch till dagens WLCSP-paket (wafer-level chip scale packages) med 0,4 mm eller ännu finare pitch och fortsätter att driva på miniatyriseringen och den höga prestandan hos elektroniska enheter.
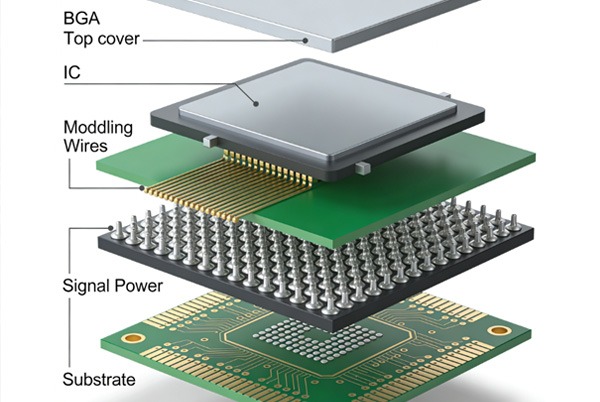
Innehållsförteckning
Aktuella designutmaningar
- Stigande stifttäthet: Moderna processorer integrerar ofta 1000+ stift, med avstånd som är komprimerade till under 0,5 mm.
- Krav på signalintegritet: Höghastighetsgränssnitt (PCIe, DDR) ställer höga krav på impedansreglering och överhörning.
- Komplexitet vid värmehantering: Ökad effekttäthet förvärrar riskerna för lokal överhettning.
- Gränser för tillverkningsprocessen: Traditionella PCB-processer står inför utmaningar som mikrovias, viafyllning och inriktningsnoggrannhet.
Layout av BGA-pad: Från teoretisk beräkning till teknisk implementering
2.1 Vetenskaplig beräkning av padstorlek
Förhållandet mellan paddiametern (d) och lödkulans diameter (dball) är inte ett fast förhållande utan bör baseras på lödvolymmodellen:

Var?
- (k): Vätningskoefficient (typiskt 0,8-0,9)
- (process): Kompensation för tillverkningstolerans (typiskt 0,05-0,1 mm)
TOPFAST Praktisk erfarenhet: För en BGA med 0,5 mm stigning rekommenderar vi:
- Paddiameter på 0,25-0,28 mm för en lödkuldiameter på 0,3 mm.
- Med NSMD-design (Non-Solder Mask Defined), med lödmasköppning 0,05-0,1 mm större än padden.
- Lägga till silkscreenmarkeringar i A1-identifieringsområdet för enklare monteringsjustering.
2.2 Pitchdesign och planering av flyktkanaler
Kapaciteten för utrymningsrouting avgör genomförbarheten av BGA-designen. Antalet routningskanaler (Nflykt) kan uppskattas genom:

Var?
- (p): Bollhöjd
- (w): Spårets bredd
- (s): Avstånd mellan spår
Flerskiktad allokeringsstrategi:
| BGA rader | Minsta signalskikt | Rekommenderad lagerallokering |
|---|---|---|
| ≤5 rader | 2 lager | Toppskikt + Innerskikt 1 |
| 6-8 rader | 3-4 lager | Översta lagret + 2-3 inre lager |
| ≥9 rader | 5+ lager | Kräver HDI eller nedgrävda vior |
Kuddar för termisk avlastning: Finjusterad balans i värmehanteringen
3.1 Termodynamiska principer och parameteroptimering
Termiska avlastningsplattor reglerar värmeflödet genom att kontrollera kopparanslutningens tvärsnittsarea. Deras termiska motståndsmodell är:

Var?
- (n): Antal ekrar (vanligen 2-4)
- (w): Ekerbredd (0,15-0,25 mm)
- (t): Kopparens tjocklek
- (L): Längd på termisk väg
Riktlinjer för optimering:
- Kraftstift: 4 ekrar, bredd 0,2-0,25 mm
- Jordstift: 2-4 variabla ekrar, justeras utifrån behov av värmeavledning
- Signal Pins: Vanligtvis direktanslutning, om inte särskilda termiska krav föreligger
3.2 Validering av TOPFAST-tillverkning
Tester med värmekamera avslöjar:
- Temperaturskillnaderna vid hörnplattorna kan uppgå till 15-20°C, vilket kräver särskild förstärkning av den termiska konstruktionen.
- Lödutbytet minskar med 8-12% när ekerbredden är <0,15 mm.
- Rekommenderas för att ge termisk avlastning runt ström-/jordplattor; använd direktanslutning för signalplattor.

Utrymningsvägar: Från traditionell Dog-Bone till avancerad Via-in-Pad
4.1 Gränser och optimering av Dog-Bone Fanout
Traditionell hundben-layout är lämplig för BGA-avstånd ≥0,8 mm. Dess kärnbegränsning är:

Där (c) är det minsta avståndet (vanligtvis 0,1 mm).
Optimeringstekniker:
- Använd ovala kuddar för att förlänga anslutningshalsen.
- Kontrollera via diameter mellan 0,2-0,25 mm.
- Använd förskjuten routing på de inre lagren för att förbättra kanalutnyttjandet.
4.2 Via-in-Pad-teknik
När pitch ≤0,65 mm blir via-in-pad en nödvändig teknik. TOPFAST erbjuder två typer av lösningar:
Typ VII Microvia (IPC-4761 Standard):
- Laserborrad, diameter 0,1-0,15 mm
- Hartsfylld + planarisering av kopparlock
- Stöder den blinda via-strukturen, vilket minskar interferens mellan skikten
Överväganden om design:
- Pad-kompensation: Den yta som upptas av via bör vara inom 20% av dynans diameter.
- Behandling av lödmask: Använd lödmaskpluggning eller fyllningsplanarisering.
- Avvägning av kostnader: Microvias ökar kostnaden med 15-25% men förbättrar routningsdensiteten med 2-3 gånger.
Samkonstruktion av flerskiktsstackup och signalintegritet
5.1 Stackup Arkitektur Planering
Empiriskt samband mellan antal BGA-pinnar (Nstift) och erforderligt antal lager (Nlager):

Exempel på konfiguration av 8-lagers kort:
| Lager | Funktion | Tjocklek | Anteckningar |
|---|---|---|---|
| L1 | Signal + Pads | 0,1 mm | Ruta de yttersta 2 raderna |
| L2 | Markplan | 0,2 mm | Massivt plan |
| L3/4 | Signalskikt | 0,15 mm | Route raderna 3-6 |
| L5/6 | Motordrivna flygplan | 0,2 mm | Delade plan |
| L7 | Signalskikt | 0,15 mm | Rulla resterande rader |
| L8 | Signal + Pads | 0,1 mm | Komponenter på undersidan |
5.2 Impedansreglering och undertryckande av överhörning
Viktiga åtgärder:
- Differentiella par: Tätt kopplad routing, längdmatchning ≤5 mils.
- Referensplan: Se till att signalskikten ligger intill solida plan.
- Via bakre borrning: För signaler >5GHz, eliminera stubbeffekter.
- TOPFAST Specialprocess: Erbjuder lokal justering av dielektrisk tjocklek för att uppfylla impedansnoggrannhet på ±7%.
Validering av tillverkningsprocesser och tillförlitlighet
6.1 DFM Checklista
- Tolerans för padstorlek: ±0,02 mm (direkt laseravbildning)
- Justering av lödmask: ±0,05 mm (bekräfta med tillverkaren)
- Lödpastatryck: 117 trådar/in²) 4. Hög ledningsdensitet (117 trådar/in²): Stencilöppningen 0,05-0,1 mm mindre än plattan
- Röntgeninspektion: Tomrumshastighet <25% (IPC-A-610 Standard)
6.2 Testobjekt för tillförlitlighet
TOPFAST rekommenderade en verifieringsprocess i tre steg:
- Steg 1 Verifiering: Mikrosektionsanalys (via koppartjocklek, fyllningskvalitet)
- Steg 2 Verifiering: Termiskt cykeltest (-55°C~125°C, 500 cykler)
- Steg 3 Verifiering: Test av sammankopplingsresistans (övervakning av kedjekoppling)
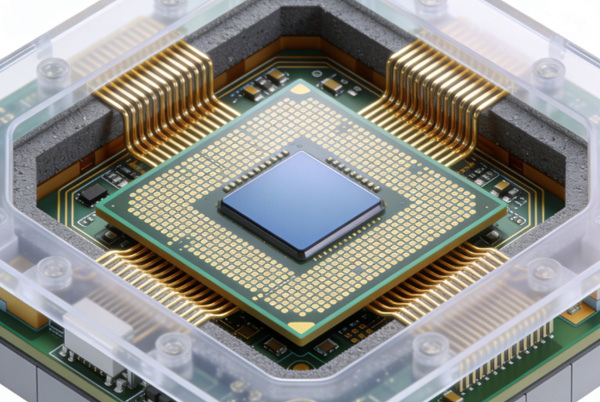
Framtida trender: Heterogen integration och avancerad paketering
Med utvecklingen av Chiplet- och 3D-IC-teknik utvecklas BGA-förpackningar mot:
- Kisel Interposer BGA: Stöder multi-chip-integration, vilket förbättrar sammankopplingsdensiteten med 10x.
- Inbäddat substrat BGA: Passiva inbäddade, vilket minskar området med 30-40%.
- Optoelektronisk integrerad BGA: Stöder optiska kanaler och bryter elektriska gränser.
Slutsats
Framgångsrik BGA-design kräver att man rör sig i fyra dimensioner:
- Elektrisk dimension: Samoptimering av signal- och effektintegritet.
- Termisk dimension: Balans mellan värmeavlastande kuddar och total värmeavledning.
- Mekanisk dimension: CTE-matchning och stressavlastning.
- Tillverkningsdimension: Optimal processförmåga och kostnad.
Baserat på erfarenheter från tusentals BGA-projekt sammanfattar TOPFAST en metodik i fyra steg: "Design - Simulering - Prototyp - Massproduktion", som hjälper kunderna att uppnå ett utbyte på 90% eller högre redan vid första konstruktionsförsöket. Kom ihåg: Den finaste BGA:n är inte en teknisk paradgren, utan den exakta skärningspunkten mellan systemkrav, designinnovation och tillverkningskapacitet.
5 vanliga frågor och svar om PCB-design för BGA-paket
A: Grundläggande princip:
Padstorlek = lödkulans diameter × 0,85 ± processkompensation
TOPFAST Rekommenderade värden:
0,5 mm delning: Paddiameter 0,3-0,35 mm
0,8 mm delning: Paddiameter 0,4-0,45 mm
1,0 mm delning: Paddiameter 0,5-0,55 mm
Viktiga överväganden:
Använd NSMD-design (lödmasköppning 0,05 mm större än pad)
Måste bekräfta processens noggrannhet med tillverkaren
Tydlig markering för A1-positionen är nödvändig
A: Obligatorisk användning:
Anslutning till stora kopparplan för kraft/jord
Stift för hög strömstyrka (>1A)
BGA hörnpositioner
Valfri användning:
Signalstiften använder vanligtvis en direkt anslutning
Strömbrytare för låg ström
TOPFAST Rekommenderade parametrar:
Antal ekrar: 4
Ekrarnas bredd: 0,15-0,25 mm
Öppningsdiameter: 0,3-0,5 mm
A: Formel för uppskattning av antalet lager:
Lager ≈ (antal stift som kräver routning) ÷ (4 × Routningsbara rader per lager) + 1 lagermarginal
TOPFAST Routing-strategi:
Yttre lager: Route yttersta 1-2 raderna
Inre lager: Använd dog-bone eller via-in-pad
Nyckel: Planera via platser tidigt
Rekommendationer per pitch:
≥0,8 mm: Fanout med hundben
0,65-0,8 mm: Delvis via-in-pad
≤0,5 mm: Fullständig via-in-pad
A: Fyra viktiga punkter:
Impedansreglering: Gradvis avsmalning från pad till spår
Undertryckande av överhörning: Höghastighetssignalavstånd ≥ 3× spårbredd
Returväg: Tillhandahåll jord via för varje signal via
Strömförsörjningens integritet: Placera frikopplingskondensatorer inom 50 mils från BGA
TOPFAST Checklista:
Matchning av differentiell parlängd ≤ 5 mils
Impedansreglering inom ±7%
Kritisk överhörning av nätverk < -40dB
A: Designfasen:
Padens ytfinish: ENIG (höghastighetssignaler) eller ImAg (kostnadskänsliga)
Stencil design: Aperturstorlek 85-90% av pad-ytan
Kontroll av avstånd: Säkerställ att minimikraven för avstånd mellan plattorna uppfylls
Tillverkningsfas:
Kontroll av tryckning av lödpasta
Röntgeninspektion (hålrumsfrekvens < 25%)
Verifiering av profil för omsmältningstemperatur
Test av elektrisk prestanda
TOPFAST Erfarenhet:
Genom att involvera tillverkaren i tidiga DFM-granskningar kan problem med massproduktion minskas med över 70%. Genom att tillhandahålla BGA-specifikationer till TOPFAST kan man få anpassade processrekommendationer.