Sinds de introductie in de jaren 1980 is de Ball Grid Array (BGA) verpakking snel uitgegroeid tot de verpakkingsvorm bij uitstek voor geïntegreerde schakelingen met hoge dichtheid, dankzij de hoge pindichtheid, uitstekende elektrische en thermische prestaties en betrouwbaarheid. De BGA-technologie is geëvolueerd van de vroege standaard BGA's met een pitch van 1,27 mm tot de huidige wafer-level chip scale packages (WLCSP) met een pitch van 0,4 mm of zelfs nog fijner, en blijft de miniaturisatie en hoge prestaties van elektronische apparaten stimuleren.
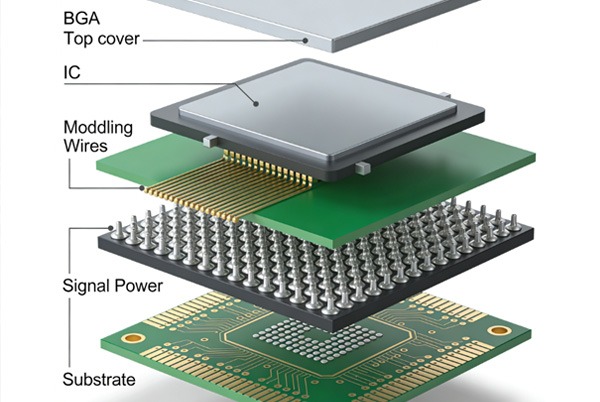
Inhoudsopgave
Huidige ontwerpuitdagingen
- Stijgende pindichtheid: Moderne processors integreren vaak meer dan 1000 pinnen, met pitches gecomprimeerd onder 0,5 mm.
- Eisen aan signaalintegriteit: Snelle interfaces (PCIe, DDR) stellen strenge eisen aan impedantieregeling en overspraakonderdrukking.
- Thermisch beheer Complexiteit: Verhoogde vermogensdichtheid verergert het risico van plaatselijke oververhitting.
- Grenswaarden productieproces: Traditionele printplaatprocessen hebben te maken met uitdagingen zoals microvia's, via-vulling en uitlijnnauwkeurigheid.
BGA-mattenlay-out: Van theoretische berekening tot technische implementatie
2.1 Wetenschappelijke berekening van de padgrootte
De relatie tussen de paddiameter (d) en de soldeerbaldiameter (dbal) is geen vaste verhouding maar moet gebaseerd zijn op het soldeervolumemodel:

Waar:
- (k): Bevochtigingscoëfficiënt (meestal 0,8-0,9)
- (proces): Compensatie voor fabricagetolerantie (gewoonlijk 0,05-0,1 mm)
TOPFAST Praktijkervaring: Voor een BGA met een pitch van 0,5 mm raden we aan:
- Paddiameter van 0,25-0,28 mm voor een soldeerbaldiameter van 0,3 mm.
- Met NSMD-ontwerp (Non-Solder Mask Defined), met soldeermaskeropening 0,05-0,1 mm groter dan het pad.
- Zeefdrukmarkeringen toevoegen in het A1-identificatiegebied voor eenvoudigere montage-uitlijning.
2.2 Ontwerp van de pitch en vluchtkanaalplanning
De ontsnappingsmogelijkheden voor de routering bepalen de haalbaarheid van het BGA-ontwerp. Het aantal routingkanalen (Nontsnappen) kan worden geschat door:

Waar:
- (p): Bal worp
- (w): Spoorbreedte
- (s): Spoorafstand
Allocatiestrategie met meerdere lagen:
| BGA-rijen | Minimale signaallagen | Aanbevolen laagtoewijzing |
|---|---|---|
| ≤5 rijen | 2 lagen | Bovenste laag + Binnenste laag 1 |
| 6-8 rijen | 3-4 lagen | Bovenste laag + 2-3 binnenste lagen |
| ≥9 rijen | 5+ lagen | HDI of ingegraven vias vereist |
Thermische ontlastingsdekens: Fijn afgesteld evenwicht in thermisch beheer
3.1 Thermodynamische principes en parameteroptimalisatie
Thermische ontlastingspads regelen de warmtestroom door de doorsnede van de koperen verbinding te regelen. Hun thermische weerstandsmodel is:

Waar:
- (n): Aantal spaken (meestal 2-4)
- (w): Spaakbreedte (0,15-0,25 mm)
- (t): Koperdikte
- (L): Lengte thermisch pad
Richtlijnen voor optimalisatie:
- Voedingspinnen: 4 spaken, breedte 0,2-0,25 mm
- Aardingspennen: 2-4 variabele spaken, aangepast aan de behoefte aan warmteafvoer
- Signaalpinnen: Gewoonlijk directe aansluiting, tenzij er speciale thermische vereisten zijn
3.2 TOPFAST productievalidatie
Thermische beeldvormingstests onthullen:
- Temperatuurverschillen bij hoekpads kunnen oplopen tot 15-20°C, waardoor speciale versterking in het thermische ontwerp nodig is.
- De soldeeropbrengst daalt met 8-12% als de spaakbreedte <0,15mm is.
- Aanbevolen om thermische ontlasting toe te voegen rond voedings-/ massakabels; gebruik directe aansluiting voor signaalkabels.

Vluchtroutes: Van traditioneel hondenbeen tot geavanceerd Via-in-Pad
4.1 Beperkingen en optimalisatie van Dog-Bone Fanout
Traditionele hondenbeen lay-out is geschikt voor BGA-pitches ≥0,8 mm. De kernbeperking is:

Waarbij (c) de minimale speling is (meestal 0,1 mm).
Optimalisatietechnieken:
- Gebruik ovale pads om de verbindingshals te verlengen.
- Controle via diameter tussen 0,2-0,25 mm.
- Gebruik verspringende routering op binnenlagen om het kanaalgebruik te verbeteren.
4.2 Via-in-pad technologie
Als de steek ≤0,65 mm is, wordt via-in-pad een noodzakelijke technologie. TOPFAST biedt twee soorten oplossingen:
Type VII Microvia (IPC-4761 norm):
- Lasergeboord, diameter 0,1-0,15 mm
- Harsgevuld + koperen kap planarisatie
- Ondersteunt de blinde via structuur, waardoor interferentie tussen lagen wordt verminderd
Ontwerpoverwegingen:
- Pad Compensatie: Het oppervlak van de via moet binnen 20% van de paddiameter liggen.
- Behandeling soldeermasker: Gebruik soldeermaskerpluggen of vul planarisatie.
- Kosten: Microvia's verhogen de kosten met 15-25% maar verbeteren de routeringsdichtheid met 2-3 keer.
Meerlagig stapelen en signaalintegriteit co-ontwerpen
5.1 Opstapelen Architectuur Planning
Empirische relatie tussen het aantal BGA-pinnen (Npinnen) en het vereiste aantal lagen (Nlagen):

Voorbeeldconfiguratie 8-laagse printplaat:
| Laag | Functie | Dikte | Opmerkingen |
|---|---|---|---|
| L1 | Signaal + pads | 0,1 mm | Routeer de buitenste 2 rijen |
| L2 | Grondvlak | 0,2 mm | Massief vlak |
| L3/4 | Signaallagen | 0,15 mm | Route rijen 3-6 |
| L5/6 | Vliegtuigen | 0,2 mm | Gesplitste vlakken |
| L7 | Signaallaag | 0,15 mm | Route resterende rijen |
| L8 | Signaal + pads | 0,1 mm | Onderdelen aan onderkant |
5.2 Impedantieregeling en overspraakonderdrukking
Belangrijkste maatregelen:
- Differentiële paren: Nauw gekoppelde routing, lengteafstemming ≤5 mils.
- Referentievlakken: Zorg ervoor dat signaallagen grenzen aan solide vlakken.
- Via terugboren: Voor signalen >5 GHz, stubeffecten elimineren.
- TOPFAST speciaal proces: Biedt plaatselijke aanpassing van de diëlektrische dikte om te voldoen aan de impedantienauwkeurigheid van ±7%.
Productieprocessen en validatie van betrouwbaarheid
6.1 DFM Checklist
- Tolerantie padgrootte: ±0,02mm (Laser Direct Imaging)
- Uitlijning soldeermasker: ±0,05mm (Bevestig met fabrikant)
- Soldeerpasta afdrukken: Stencilopening 0,05-0,1 mm kleiner dan pad
- Röntgeninspectie: Leegloopsnelheid <25% (IPC-A-610 norm)
6.2 Items voor betrouwbaarheidstests
TOPFAST heeft een verificatieproces in drie fasen aanbevolen:
- Stap 1 Verificatie: Microsectieanalyse (via koperdikte, vulkwaliteit)
- Stap 2 Verificatie: Thermische cyclustest (-55°C~125°C, 500 cycli)
- Stap 3 Verificatie: Test van de interconnectieweerstand (bewaking van serieschakeling)
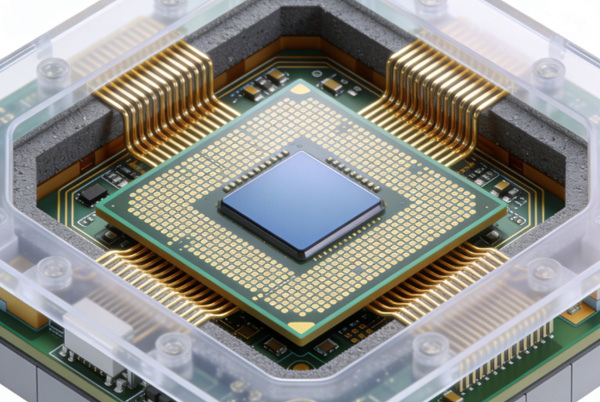
Toekomstige trends: Heterogene integratie en geavanceerde verpakking
Met de ontwikkeling van Chiplet- en 3D-IC-technologieën evolueert BGA-verpakking in de richting van:
- Silicium Interposer BGA: Ondersteunt multi-chip integratie, waardoor de interconnectiedichtheid met 10x wordt verbeterd.
- Geïntegreerd substraat BGA: Passieve materialen ingebed, waardoor de oppervlakte 30-40% kleiner wordt.
- Opto-elektronische geïntegreerde BGA: Ondersteunt optische kanalen, waardoor elektrische grenzen worden doorbroken.
Conclusie
Succesvol BGA-ontwerp vereist het doorkruisen van vier dimensies:
- Elektrische dimensie: Co-optimalisatie van signaal/vermogen integriteit.
- Thermische dimensie: Balans tussen thermische ontlastingspads en algehele warmteafvoer.
- Mechanische dimensie: CTE-matching en stressverlichting.
- Productie dimensie: Optimaal procesvermogen en kosten.
Op basis van de ervaring van duizenden BGA-projecten vat TOPFAST een vierstappenmethode samen: "Ontwerp - Simulatie - Prototype - Massaproductie", die klanten helpt om opbrengsten van 90% of hoger te behalen bij hun eerste ontwerppoging. Denk eraan: De BGA met de beste pitch is geen technologisch paradepaardje, maar het precieze snijpunt van systeemvereisten, ontwerpinnovatie en productiecapaciteit.
5 veelvoorkomende vragen over het PCB-ontwerp van BGA-pakketten
A: Kernprincipe:
Padgrootte = diameter soldeerbal × 0,85 ± procescompensatie
Aanbevolen TOPFAST-waarden:
0,5mm steek: Tampondiameter 0,3-0,35 mm
0,8mm steek: Tampondiameter 0,4-0,45 mm
1,0 mm steek: Paddiameter 0,5-0,55mm
Belangrijke overwegingen:
Gebruik NSMD-ontwerp (soldeermaskeropening 0,05 mm groter dan pad)
Moet de procesnauwkeurigheid bevestigen met de fabrikant
Duidelijke markering voor de A1-positie is essentieel
A: Verplicht gebruik:
Aansluiting op grote koperen voedings-/ massavlakken
Pinnen met hoge stroomsterkte (>1A)
BGA-hoekposities
Optioneel gebruik:
Signaalpennen gebruiken meestal een directe verbinding
Voedingspennen met lage stroomsterkte
Aanbevolen TOPFAST-parameters:
Aantal spaken: 4
Spaakbreedte: 0,15-0,25 mm
Diameter opening: 0,3-0,5mm
A: Formule voor het schatten van het aantal lagen:
Lagen ≈ (aantal pinnen die gerouteerd moeten worden) ÷ (4 × routeerbare rijen per laag) + 1 laag marge
TOPFAST-routeringsstrategie:
Buitenste lagen: Route buitenste 1-2 rijen
Binnenlagen: Gebruik hondenbot of via-in-pad
Sleutel: Plan via locaties vroeg
Aanbevelingen door Pitch:
≥0,8 mm: Hond-been fanout
0,65-0,8 mm: Gedeeltelijke via-in-pad
≤0,5 mm: Volledige via-in-pad
A: Vier belangrijke punten:
Impedantieregeling: Geleidelijke afname van pad tot spoor
Overspraakonderdrukking: Snelle signaalafstand ≥ 3× spoorbreedte
Retourpad: Zorg voor aarde via voor elk signaal via
Integriteit van de voeding: Plaats ontkoppelingscondensatoren binnen 50 mils van BGA
TOPFAST Checklist:
Afstemming differentiële paarlengte ≤ 5 mils
Impedantieregeling binnen ±7%
Kritische netwerkoverspraak < -40dB
A: Ontwerpfase:
Pad oppervlakafwerking: ENIG (hogesnelheidssignalen) of ImAg (kostengevoelig)
Stencilontwerp: Diafragmagrootte 85-90% van het stootkussenoppervlak
Afstandscontrole: Controleer of aan de minimale vrije ruimte voor de pad is voldaan
Productiefase:
Inspectie afdrukken soldeerpasta
Röntgeninspectie (leegloop < 25%)
Verificatie van het reflowtemperatuurprofiel
Testen van elektrische prestaties
Ervaring met TOPFAST:
Het betrekken van de fabrikant bij vroege DFM-beoordelingen kan problemen met massaproductie met meer dan 70% verminderen. Door BGA-specificaties aan TOPFAST te verstrekken, kunnen procesaanbevelingen op maat worden gemaakt.