PCB de Interconexão de Alta Densidade
Índice
O que é o IDH?
A HDI, que se refere a uma maior densidade de cablagem por unidade de área do que as placas de circuitos impressos convencionais, é uma placa de circuito impresso (PCB) que atinge níveis mais elevados de integração de componentes electrónicos através de cablagem microfina, estruturas de via microscópicas e cablagem densa. Estas placas utilizam fios e aberturas mais finos (≤ 100 µm/0,10 mm), vias mais pequenas (<150 µm) e pads (20 pads/cm2) do que a tecnologia PCB convencional.
Caraterísticas principais
- Largura/espaço de linha mais fino: tipicamente ≤100 µm (0,10 mm), muito inferior ao das placas de circuito impresso convencionais (tipicamente 150 µm+).
- Pequenos orifícios de passagem:
- Vias embutidas por laser cego: <150 µm de diâmetro, perfurado a laser para ligações de alta densidade entre camadas.
- Furos empilhados/escalonados: Melhorar a utilização do espaço vertical e reduzir as necessidades de camadas.
- Elevada densidade de almofadas: >20 pads/cm² para suportar chips com vários pinos (por exemplo, embalagens BGA, CSP).
- Materiais finos: Utilização de substratos de baixa constante dieléctrica e elevada estabilidade (por exemplo, FR4, poliimida).
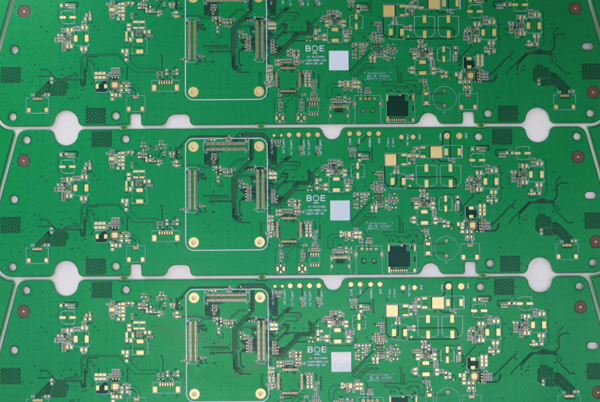
Principais caraterísticas das placas HDI (vs. PCB convencional)
1. Conceção de microvias (perfuração a laser dominada)
- Escolha da tecnologia: As placas HDI utilizam normalmente perfuração a laser (diâmetros de furo tipicamente ≤150µm) em vez de perfuração mecânica. As razões incluem:
- Limites de perfuração mecânica: As agulhas de perfuração de 0,15 mm são fáceis de partir, têm requisitos de RPM elevados e baixa eficiência, e incapacidade de realizar o controlo de profundidade de buracos cegos enterrados.
- Vantagem do laser: Pode processar furos minúsculos (por exemplo, 50µm), suporta HDI de qualquer camada, não tem contacto físico e tem um rendimento elevado.
2. Desenhos de anéis de microvia e de furo Diâmetro da via ≤150µm
- Vias ≤150µm e vias (pads) ≤250µm, libertando espaço de disposição através do estreitamento da via.
- Exemplo: Se o diâmetro da abertura for reduzido de 0,30 mm para 0,10 mm (vias laser), o diâmetro da almofada pode ser reduzido de 0,60 mm para 0,35 mm, economizando área 67%.
- Perfuração direta no bloco (Via-in-Pad): optimiza ainda mais a disposição dos componentes BGA/SMD e aumenta a densidade.
3. Elevada densidade de juntas de soldadura (>130 juntas/in²)
- A densidade das almofadas de soldadura determina a integração dos componentes. O HDI realiza módulo multifuncional montagem de alta densidade (por exemplo, placas-mãe de telemóveis) através de orifícios/fios micro-miniatura.
4. Elevada densidade de cablagem (>117 fios/in²)
- Para corresponder ao aumento dos componentes, a densidade das linhas tem de ser aumentada em simultâneo. A HDI consegue uma cablagem complexa através de cablagem fina (largura/espaçamento da linha ≤100µm) e empilhamento multicamadas.
5. Linha fina (largura/espaço da linha ≤ 3 mil/75µm)
- Norma teórica: 75µm/75µm, mas normalmente utilizado na prática, 100µm/100µm. Motivo:
- Custo do processoO processo de 75µm é exigente em termos de equipamento/materiais, tem baixo rendimento, poucos fornecedores e um custo elevado.
- Equilíbrio preço/desempenho: A solução de 100 µm estabelece um equilíbrio entre densidade e custo e é adequada para a maioria das necessidades da eletrónica de consumo.
Principais benefícios do HDI
| Dimensão | Direção HDI | PCB tradicional |
|---|---|---|
| Tecnologia de perfuração | Perfuração a laser (furos cegos enterrados, camadas arbitrárias) | Perfuração mecânica (baseada em furos passantes) |
| Diâmetro do furo/anel do furo | ≤150µm/≤250µm | ≥200µm/≥400µm |
| Densidade da cablagem | >117 fios/in² | <50 fios/in² |
| Largura/Passo do fio | ≤100µm (corrente principal) | ≥150µm |
A HDI promove a miniaturização e o elevado desempenho dos produtos electrónicos através de microvia, linha fina e interligações de alta densidadee é uma tecnologia fundamental para a 5G, a IA e os dispositivos portáteis.

Folha de especificações técnicas de PCB HDI
| Caraterística | Especificações técnicas da placa de circuito impresso HDI |
|---|---|
| Camadas | Padrão: 4-22 camadas Avançado: Até 30 camadas |
| Principais destaques | - Maior densidade de almofadas - Traço/espaço mais fino (≤75µm) - Microvias (cegas/enterradas, interconexão de qualquer camada) - Design Via-in-Pad |
| Construção de IDH | 1+N+1, 2+N+2, 3+N+3, 4+N+4, Qualquer camada (ELIC), Ultra HDI (I&D) |
| Materiais | FR4 (padrão/alto desempenho), FR4 sem halogéneo, Rogers (para aplicações de alta frequência) |
| Peso do cobre (acabado) | 18μm - 70μm |
| Min. Traço/Espaço | 0,075mm / 0,075mm (75µm/75µm) |
| Espessura da placa de circuito impresso | 0,40 mm - 3,20 mm |
| Máximo. Tamanho da placa | 610 mm × 450 mm (limitado pela capacidade de perfuração a laser) |
| Acabamento da superfície | OSP, ENIG, estanho de imersão, prata de imersão, ouro eletrolítico, dedos de ouro |
| Mín. Tamanho do furo | Perfuração mecânica: 0,15 mm Perfuração a laser: - Padrão: 0,10mm (100µm) - Avançado: 0,075mm (75µm) |
Aplicações e principais vantagens das placas HDI
I. Principais áreas de aplicação das placas HDI
Com o avanço da tecnologia de semicondutores no sentido da miniaturização e do elevado desempenho, a tecnologia HDI tornou-se um elemento essencial para a eletrónica moderna, dominando particularmente os seguintes domínios:
- Comunicações móveis
- Smartphones (4G/5G): O encaminhamento de alta densidade suporta módulos de várias câmaras, antenas 5G e processadores de alta velocidade (por exemplo, chips embalados em BGA).
- Equipamento da estação de base: A transmissão de sinais de alta frequência (por exemplo, bandas de ondas milimétricas) depende dos materiais de baixa perda do HDI (por exemplo, Rogers).
- Eletrónica de consumo
- Dispositivos portáteis: Os designs ultra-finos (por exemplo, placas-mãe de smartphones dobráveis, auriculares TWS) requerem o empilhamento de camadas finas do HDI (estrutura 1+N+1).
- Câmaras digitais/AR/VR: Sensores de alta resolução e módulos miniaturizados dependem de microvias (<75µm) e da tecnologia Via-in-Pad.
- Eletrónica automóvel
- Sistemas avançados de assistência ao condutor (ADAS): Os sistemas de radar e de infotainment exigem a elevada fiabilidade do HDI (resistência ao calor, resistência às vibrações).
- Computação de alto desempenho
- Servidores/GPUs de IA: A alta condutividade e o design térmico suportam a transmissão de alta corrente (espessura de cobre ≥70µm).
II. As vantagens "quatro altos e um baixo" da tecnologia HDI
| Vantagem | Implementação técnica | Valor de aplicação |
|---|---|---|
| Roteamento de alta densidade | Traço/espaço ≤75µm, microvias (perfuração a laser) | Reduz a área da placa de circuito impresso em >30%, diminuindo o tamanho do produto final |
| Alta frequência e alta velocidade | Materiais de baixo Dk (por exemplo, PTFE), controlo da impedância (±5%) | Suporta 5G/6G mmWave e integridade de sinal SerDes de alta velocidade |
| Alta condutividade | Interligação de qualquer camada (ELIC), tecnologia de revestimento de enchimento de vias | Reduz o atraso do sinal entre camadas, melhora os débitos de dados |
| Elevada fiabilidade do isolamento | Substratos sem halogéneo, laminação de precisão (taxa de expansão ≤3%) | Cumpre a certificação automóvel AEC-Q200, prolonga a vida útil em 50% |
| Baixo custo | Menos camadas (por exemplo, substituição de PCB com orifícios de passagem de 8 camadas por HDI de 4 camadas), perfuração automatizada a laser (rendimento >98%) | Reduz o custo total em 15%-20% |
III. Perspectivas do mercado e dados de apoio
- Tendência de crescimento: De 2000 a 2008, a produção global de placas HDI cresceu a uma taxa de crescimento anual (CAGR) de >14% (dados da Prismark). Em 2023, a dimensão do mercado excedeu $12 mil milhões, com uma CAGR projectada para 2030 de 8,3%.
- Evolução tecnológica: O Ultra HDI (traço/espaço ≤40µm) e a tecnologia de componentes incorporados impulsionarão ainda mais o desenvolvimento da AIoT e dos dispositivos portáteis.
Com as suas caraterísticas de "quatro altos e um baixo", a tecnologia HDI é um dos principais motores do avanço da indústria eletrónica, com um enorme potencial nas comunicações 6G, nos veículos autónomos e na computação quântica.
Classificação das placas HDI
As placas HDI são classificadas em três tipos principais com base no método de empilhamento e na contagem de laminação de vias cegas:
(1) 1+N+1 Tipo
- Estrutura: Apresenta uma única camada de laminação para interligações de alta densidade.
- Caraterísticas:
- A solução HDI mais económica
- Adequado para projectos com complexidade moderada
- Aplicações típicas: Smartphones de entrada de gama, eletrónica de consumo
(2) i+N+i (i≥2) Tipo
- Estrutura: Incorpora duas ou mais camadas de laminação para interligações de alta densidade.
- Caraterísticas principais:
- Suporta configurações de microvia escalonadas ou empilhadas
- Os projectos avançados utilizam frequentemente microvias empilhadas cheias de cobre
- Proporciona uma maior densidade de encaminhamento e integridade do sinal
- Aplicações:
- Dispositivos móveis de gama média-alta
- Equipamento de rede
- Eletrónica automóvel
(3) Tipo de interconexão em qualquer camada (ELIC)
- Estrutura: Todas as camadas utilizam interligações de alta densidade com microvias empilhadas cheias de cobre.
- Vantagens:
- Permite uma total liberdade de conceção para as ligações entre camadas
- Solução óptima para componentes com um número ultra elevado de pinos (por exemplo, CPUs, GPUs)
- Maximiza a utilização do espaço em designs compactos
- Casos de utilização típicos:
- Smartphones topo de gama
- Computação de alto desempenho
- Dispositivos portáteis avançados
Comparação técnica
| Tipo | Contagem de laminação | Via Estrutura | Fator de custo | Aplicações típicas |
|---|---|---|---|---|
| 1+N+1 | Laminação simples | Microvias de base | Mais baixo | Eletrónica de consumo de nível básico |
| i+N+i (i≥2) | Laminação múltipla | Microvias empilhadas/escalonadas | Moderado | Telemóvel/redes de gama média |
| ELIC | Toda a camada | Vias empilhadas com enchimento de cobre | Mais alto | Computação topo de gama/móvel |
Este sistema de classificação ajuda os projectistas a selecionar a tecnologia HDI adequada com base em requisitos de desempenho, complexidade e considerações de custo. A evolução de 1+N+1 para ELIC representa capacidades crescentes para suportar aplicações electrónicas mais avançadas.
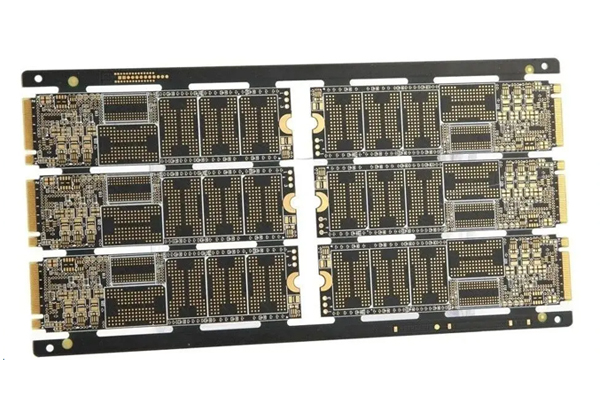
Requisitos de desempenho do material de PCB HDI/BUM
O desenvolvimento de materiais para placas de circuitos impressos HDI centrou-se sempre na satisfação dos requisitos "quatro altos e um baixo" (alta densidade, alta frequência, alta condutividade, alta fiabilidade e baixo custo). As necessidades crescentes de miniaturização e desempenho das placas de circuitos impressos estão a ser satisfeitas através da melhoria de propriedades como a resistência à electromigração e a estabilidade dimensional.
1. Materiais pré-impregnados (PP)
- Composição: Resina + materiais reforçados (normalmente fibra de vidro)
- Vantagens:
- Baixo custo
- Boa rigidez mecânica
- Ampla aplicabilidade
- Limitações:
- Fiabilidade moderada (resistência CAF mais fraca)
- Menor resistência ao descolamento da almofada (não adequado para aplicações exigentes de testes de queda)
- Aplicações típicas: Eletrónica de consumo de gama média-baixa (por exemplo, smartphones económicos)
2. Materiais de cobre revestidos a resina (RCC)
- Tipos:
- Película PI metalizada
- Película PI + folha de cobre laminada com adesivo ("Pure PI")
- Película de PI fundida (PI líquida curada em folha de cobre)
- Vantagens:
- Excelente capacidade de fabrico
- Elevada fiabilidade
- Resistência superior ao descolamento da almofada (ideal para aplicações de teste de queda)
- Tecnologia de perfuração a laser microvia activada
- Limitações:
- Custo mais elevado
- Menor rigidez global (potenciais problemas de deformação)
- Impacto: Pioneira na transição da embalagem SMT para CSP
3. Materiais pré-impregnados perfuráveis a laser (LDP)
- Posicionamento: Equilíbrio custo-desempenho entre PP e RCC
- Vantagens:
- Melhor resistência ao CAF do que o PP
- Melhoria da uniformidade da camada dieléctrica
- Cumpre/excede as normas internacionais em matéria de resistência ao descolamento de almofadas
- Aplicações: Dispositivos móveis e electrónicos de gama média-alta
4. Materiais de polímeros de cristais líquidos (LCP)
- Propriedades principais:
- Constante dieléctrica ultra-baixa (Dk=2,8 @1GHz)
- Tangente de perda mínima (0,0025)
- Retardamento de chama inerente (sem halogéneos)
- Estabilidade dimensional superior
- Vantagens:
- Ideal para projectos de alta frequência/alta velocidade
- Amigo do ambiente
- Desafiar o domínio tradicional da PI
- Aplicações: Circuitos de RF/micro-ondas topo de gama, acondicionamento avançado
Guia de seleção de materiais
| Material | Custo | Fiabilidade | Alto-frequência | Rigidez | Melhor para |
|---|---|---|---|---|---|
| PP | Baixa | Moderado | Não | Elevado | Dispositivos de consumo económicos |
| CCR | Elevado | Excelente | Moderado | Baixa | Teste de queda de aplicações sensíveis |
| LDP | Médio | Bom | Limitada | Elevado | Dispositivos móveis de qualidade superior |
| LCP | Muito elevado | Excecional | Sim | Médio | 5G/RF/acondicionamento avançado |
Diferença no processo de fabrico de placas de circuito impresso entre placas com núcleo e placas sem núcleo
I. Processo de fabrico de IDH com base no núcleo
1. Caraterísticas do quadro principal
- Conceção estrutural:
- Utiliza orifícios de passagem ou estruturas híbridas enterradas/cegas/por orifícios de passagem (normalmente 4-6 camadas)
- Construção opcional com núcleo metálico (dissipação térmica melhorada)
Parâmetros técnicos:
| Parâmetro | Conselho de Administração | Camadas de acumulação |
|---|---|---|
| Diâmetro do orifício de passagem | ≥0,2 mm | ≤0,15mm (microvias) |
| Largura do traço/espaço | ≥0,08mm | ≤0,08mm |
| Densidade de interconexão | Baixa | Densidade ultra-alta |
2. Funções essenciais do Conselho de Administração
- Suporte mecânico (assegura a rigidez)
- Ponte de interconexão eléctrica entre as camadas de acumulação
- Gestão térmica (especialmente para placas com núcleo metálico)
3. Principais processos de pré-tratamento
- Através de tratamento: Preenchimento de vias + planarização de superfícies
- Tratamento de superfície: Cobreamento sem eletrólise + galvanoplastia (1-3µm de espessura)
- Transferência de padrões: Imagem direta por laser LDI (precisão de ±5µm)
II. Tecnologia inovadora HDI sem núcleo
1. Tecnologias representativas
- ALIVH (Furo de via intersticial de qualquer camada)
- B²IT (Tecnologia de interconexão de lombadas enterradas)
2. Vantagens revolucionárias
| Comparação | IDH com base no núcleo | HDI sem núcleo |
|---|---|---|
| Estrutura | Núcleo + zonas de acumulação | Conceção de camadas homogéneas |
| Densidade de interconexão | Variação significativa da camada | Densidade ultra-alta uniforme (+40% vs. núcleo) |
| Transmissão de sinais | Caminhos mais longos (atraso induzido pelo núcleo) | Caminhos mais curtos possíveis |
| Controlo da espessura | Limitado pelo núcleo (≥0,4 mm) | Pode atingir <0,2 mm |
3. Inovações do processo principal
- Interligação de camadas:
- Substitui o cobre eletrolítico por pasta condutora ou por saliências de cobre
- Ablação por laser para microvias de qualquer camada (≤50µm de diâmetro)
- Garantia de fiabilidade:
- Rugosidade da superfície à nanoescala (Ra≤0,5µm)
- Materiais dieléctricos de baixa cura (Tg≥200℃)
Observações finais
Impulsionadas pelos avanços na perfuração a laser, na ciência dos materiais e no empilhamento de várias camadas, as PCB HDI representam a vanguarda da miniaturização e da eletrónica de elevado desempenho. A tecnologia HDI continuará a evoluir à medida que os dispositivos exigem velocidades mais elevadas, menor latência e maior fiabilidade, ultrapassando os limites do fabrico de PCB.










Publicações relacionadas