Yüksek Yoğunluklu Ara Bağlantı PCB
İçindekiler
HDI nedir?
Geleneksel baskılı devre kartlarına göre birim alan başına daha yüksek kablo yoğunluğu anlamına gelen HDI, gelişmiş bir baskılı devre kartı (PCB) teknolojisi, mikro ince kablolama, mikroskobik geçiş yapıları ve yoğun kablolama yoluyla daha yüksek elektronik bileşen entegrasyonu seviyelerine ulaşır. Bu kartlarda geleneksel PCB teknolojisine kıyasla daha ince teller ve boşluklar (≤ 100 µm/0,10 mm), daha küçük yollar (<150 µm) ve pedler (<400 µm/0,40 mm) ve daha yüksek ped yoğunlukları (>20 ped/cm2) kullanılmaktadır.
Temel Özellikler
- Daha ince çizgi genişliği/aralığı: tipik olarak ≤100 µm (0,10 mm), geleneksel PCB'lerden (tipik olarak 150 µm+) çok daha düşüktür.
- Delikler aracılığıyla küçük:
- Lazer kör gömülü vialar: <150 µm çapında, katmanlar arasında yüksek yoğunluklu bağlantılar için lazerle delinmiştir.
- İstiflenmiş/kademeli delikler: Dikey alan kullanımını iyileştirin ve katman gereksinimlerini azaltın.
- Yüksek ped yoğunluğu: >Çok pimli çipleri (örneğin BGA, CSP paketleri) desteklemek için 20 ped/cm².
- İnce malzemeler: Düşük dielektrik sabiti, yüksek stabilite substratlarının kullanımı (örn. FR4, poliimid).
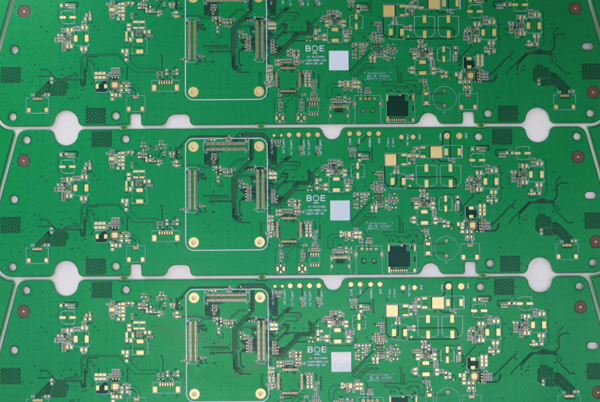
HDI kartların temel özellikleri (geleneksel PCB'ye kıyasla)
1.Mikrovia tasarımı (lazer delme hakim)
- Teknoloji Seçimi: HDI kartları yaygın olarak şunları kullanır lazer delme (delik çapları tipik olarak ≤150µm) mekanik delme yerine. Bunun nedenleri şunlardır:
- Mekanik Delme Sınırları: 0.15mm delme iğnelerinin kırılması kolaydır, yüksek RPM gereksinimleri ve düşük verimlilikleri vardır ve derinlik kontrolünü gerçekleştiremezler. kör gömülü delikler.
- Lazer Avantajı: Küçük delikleri (örn. 50µm) işleyebilir, destekler Herhangi bir katman HDIve fiziksel teması yoktur ve yüksek verimlidir.
2. Microvia ve Delikli Halka Tasarımları Via Çapı ≤150µm
- Vias ≤150µm ve vialar (pedler) ≤250µm, via'yı daraltarak yerleşim alanını serbest bırakır.
- Örnek: Açıklık çapı 0,30 mm'den 0,10 mm'ye düşürülürse (lazer yolları), ped çapı 0,60 mm'den 0,35 mm'ye düşürülebilir, 67 alan tasarrufu.
- Doğrudan Tampon Delme (Via-in-Pad)BGA/SMD bileşen yerleşimini daha da optimize eder ve yoğunluğu artırır.
3.Yüksek Lehim Bağlantı Yoğunluğu (>130 bağlantı/in²)
- Lehim pedi yoğunluğu bileşen entegrasyonunu belirler. HDI şunları gerçekleştirir çok fonksiyonlu modül mikro minyatür delikler/teller aracılığıyla yüksek yoğunluklu montaj (örn. cep telefonu anakartları).
4.Yüksek kablo yoğunluğu (>117 tel/in²)
- Bileşenlerin artışını eşleştirmek için hat yoğunluğunun aynı anda artırılması gerekir. HDI karmaşık kablolamayı şu yollarla gerçekleştirir ince kablolama (çizgi genişliği/aralığı ≤100µm) ve çok katmanlı istifleme.
5. İnce çizgi (çizgi genişliği/boşluk ≤ 3 mil/75µm)
- Teorik standart: 75µm/75µm, ancak pratikte yaygın olarak 100µm/100µm kullanılır. Sebep:
- Süreç maliyeti: 75µm süreci ekipman/malzeme, düşük verim, az sayıda tedarikçi ve yüksek maliyet gerektirmektedir.
- Fiyat/Performans Dengesi: 100µm çözümü yoğunluk ve maliyet arasında bir denge kurar ve çoğu tüketici elektroniği ihtiyacı için uygundur.
HDI'ın Temel Faydaları
| Boyut | HDI Yönetim Kurulu | Geleneksel PCB |
|---|---|---|
| Sondaj Teknolojisi | Lazer Delme (Kör Gömülü Delikler, Keyfi Katmanlar) | Mekanik Delme (Delik Tabanlı) |
| Delik Çapı/Delik Halkası | ≤150µm/≤250µm | ≥200µm/≥400µm |
| Kablolama Yoğunluğu | >117 tel/in² | <50 tel/in² |
| Tel Genişliği/Aralığı | ≤100µm (Ana akım) | ≥150µm |
HDI, elektronik ürünlerin minyatürleştirilmesini ve yüksek performansını şu yollarla teşvik eder microvia, ince çizgi ve yüksek yoğunluklu ara bağlantılarve 5G, yapay zeka ve taşınabilir cihazlar için kilit bir teknolojidir.

HDI PCB Teknik Özellikler Sayfası
| Özellik | HDI PCB Teknik Özellikleri |
|---|---|
| Katmanlar 2025 | Standart: 4-22 katmanlar Gelişmiş: 30 katmana kadar |
| Önemli Noktalar | – Daha yüksek ped yoğunluğu – Daha ince iz/boşluk (≤75µm) – Mikroviyalar (kör/gömülü, herhangi bir katman ara bağlantısı) – Via-in-Pad tasarımı |
| HDI Oluşturma | 1+N+1, 2+N+2, 3+N+3, 4+N+4, Herhangi bir katman (ELIC), Ultra HDI (R&D) |
| Malzemeler | FR4 (Standart/Yüksek performanslı), Halojensiz FR4, Rogers (yüksek frekanslı uygulamalar için) |
| Bakır Ağırlığı (Bitmiş) | 18μm - 70μm |
| Min. İz / Alan | 0,075 mm / 0,075 mm (75µm/75µm) |
| PCB Kalınlığı | 0.40mm - 3.20mm |
| Maks. Pano Boyutu | 610mm × 450mm (lazer delme kapasitesi ile sınırlıdır) |
| Yüzey İşlemi | OSP, ENIG, Daldırma Kalay, Daldırma Gümüş, Elektrolitik Altın, Altın Parmaklar |
| Min. Delik Boyutu | Mekanik Sondaj: 0.15mm Lazer Delme: – Standart: 0,10 mm (100µm) – Gelişmiş: 0,075 mm (75µm) |
HDI Panoların Uygulamaları ve Temel Avantajları
I.HDI Panolarının Temel Uygulama Alanları
Yarı iletken teknolojisinin minyatürleştirme ve yüksek performansa doğru ilerlemesiyle, HDI teknolojisi modern elektronik için kritik bir kolaylaştırıcı haline gelmiştir ve özellikle aşağıdaki alanlara hakimdir:
- Mobil İletişim
- Akıllı Telefonlar (4G/5G): Yüksek yoğunluklu yönlendirme, çoklu kamera modüllerini, 5G antenlerini ve yüksek hızlı işlemcileri (örn. BGA paketlenmiş çipler) destekler.
- Baz İstasyonu Ekipmanları: Yüksek frekanslı sinyal iletimi (örn. milimetre dalga bantları) HDI’nın düşük kayıplı malzemelerine (örn. Rogers) dayanır.
- Tüketici Elektroniği
- Taşınabilir Cihazlar: Ultra ince tasarımlar (örneğin, katlanabilir akıllı telefon anakartları, TWS kulaklıklar) HDI’nın ince katman istiflemesini (1+N+1 yapısı) gerektirir.
- Dijital Kameralar/AR/VR: Yüksek çözünürlüklü sensörler ve minyatür modüller mikrovias (<75µm) ve Via-in-Pad teknolojisine bağlıdır.
- Otomotiv Elektroniği
- Gelişmiş Sürücü Destek Sistemleri (ADAS): Radar ve bilgi-eğlence sistemleri HDI’nın yüksek güvenilirliğini (ısı direnci, titreşim direnci) talep eder.
- Yüksek Performanslı Hesaplama
- Yapay Zeka Sunucuları/GPU'ları: Yüksek iletkenlik ve termal tasarım yüksek akım iletimini destekler (bakır kalınlığı ≥70µm).
II.HDI Teknolojisinin “Dört Yüksek ve Bir Düşük” Avantajları
| Avantaj | Teknik Uygulama | Uygulama Değeri |
|---|---|---|
| Yüksek Yoğunluklu Yönlendirme | İz/boşluk ≤75µm, mikrovias (lazer sondaj) | PCB alanını > oranında azaltarak son ürün boyutunu küçültür |
| Yüksek Frekanslı & Yüksek Hızlı | Düşük Dk malzemeler (örn. PTFE), empedans kontrolü (±%5) | 5G/6G mmWave ve yüksek hızlı SerDes sinyal bütünlüğünü destekler |
| Yüksek İletkenlik | Herhangi bir katman ara bağlantısı (ELIC), via-dolgu kaplama teknolojisi | Katmanlar arası sinyal gecikmesini azaltır, veri hızlarını artırır |
| Yüksek İzolasyon Güvenilirliği | Halojen içermeyen alt tabakalar, hassas laminasyon (≤%3 genleşme oranı) | Otomotiv AEC-Q200 sertifikasını karşılar, kullanım ömrünü uzatır |
| Düşük Maliyetli | Daha az katman (örneğin, 8 katmanlı delikli PCB'lerin 4 katmanlı HDI ile değiştirilmesi), otomatik lazer delme (verim >) | Toplam maliyeti - oranında azaltır |
III. Pazar Görünümü ve Destekleyici Veriler
- Büyüme Trendi: 2000-2008 yılları arasında küresel HDI levha üretimi >'lük bir YBBO ile büyümüştür (Prismark verileri). 2023 yılına gelindiğinde pazar büyüklüğü 12 milyar doları aşmış ve 2030 YBBO'su %8,3 olarak öngörülmüştür.
- Teknoloji Evrimi: Ultra HDI (iz/uzay ≤40µm) ve gömülü bileşen teknolojisi, AIoT ve giyilebilir cihaz gelişimini daha da ileriye taşıyacaktır.
HDI teknolojisi, “Dört Yüksek ve Bir Düşük” özellikleriyle, 6G iletişim, otonom araçlar ve kuantum bilişim alanlarında muazzam bir potansiyele sahip olarak elektronik endüstrisinin ilerlemesinde temel bir itici güç görevi görmektedir.
HDI Panolarının Sınıflandırılması
HDI levhalar, istifleme yöntemine ve kör yolların laminasyon sayısına göre üç ana tipe ayrılır:
(1) 1+N+1 Tip
- Yapı: Yüksek yoğunluklu ara bağlantılar için tek bir laminasyon katmanına sahiptir.
- Özellikler:
- En uygun maliyetli HDI çözümü
- Orta düzeyde karmaşıklığa sahip tasarımlar için uygundur
- Tipik uygulamalar:Giriş seviyesi akıllı telefonlar, tüketici elektroniği
(2) i+N+i (i≥2) Tip
- Yapı: Yüksek yoğunluklu ara bağlantılar için iki veya daha fazla laminasyon katmanı içerir.
- Temel Özellikler:
- Kademeli veya istiflenmiş mikrovia konfigürasyonlarını destekler
- Gelişmiş tasarımlarda genellikle bakır dolgulu istiflenmiş mikroviyalar kullanılır
- Gelişmiş yönlendirme yoğunluğu ve sinyal bütünlüğü sağlar
- Uygulamalar:
- Orta ila yüksek seviye mobil cihazlar
- Ağ ekipmanları
- Otomotiv elektroniği
(3) Herhangi Katmanlı Ara Bağlantı (ELIC) Tipi
- Yapı: Tüm katmanlar, istiflenmiş bakır dolgulu mikroviyalar ile yüksek yoğunluklu ara bağlantılar kullanır.
- Avantajlar 2025:
- Katmanlar arası bağlantılar için tam tasarım özgürlüğü sağlar
- Ultra yüksek pin sayılı bileşenler (örn. CPU'lar, GPU'lar) için optimum çözüm
- Kompakt tasarımlarda alan kullanımını en üst düzeye çıkarır
- Tipik Kullanım Örnekleri:
- Amiral gemisi akıllı telefonlar
- Yüksek performanslı hesaplama
- Gelişmiş giyilebilir cihazlar
Teknik Karşılaştırma
| Tip | Laminasyon Sayısı | Yapı Üzerinden | Maliyet Faktörü | Tipik Uygulamalar |
|---|---|---|---|---|
| 1+N+1 | Tek laminasyon | Temel mikrovialar | En düşük | Giriş seviyesi tüketici elektroniği |
| i+N+i (i≥2) | Çoklu laminasyonlar | Yığılmış/kademeli mikroviyalar | Orta düzeyde | Orta sınıf mobil/ağ |
| ELIC | Tüm katmanlar | Bakır dolgulu istiflenmiş vialar | En yüksek | Üst düzey bilgisayar/mobil |
Bu sınıflandırma sistemi, tasarımcıların performans gereksinimleri, karmaşıklık ve maliyet hususlarına göre uygun HDI teknolojisini seçmelerine yardımcı olur.1+N+1'den ELIC'e evrim, daha gelişmiş elektronik uygulamaları desteklemek için artan yetenekleri temsil eder.
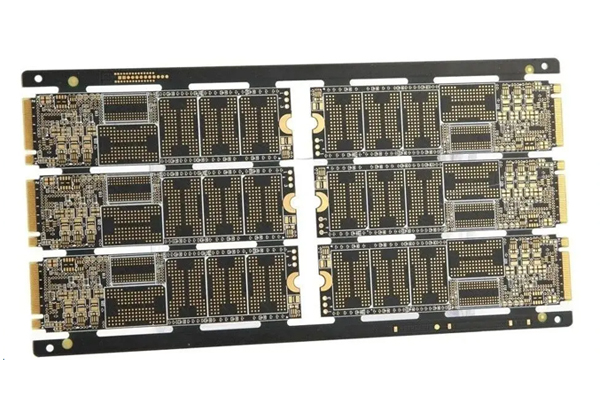
HDI/BUM PCB Malzeme Performans Gereksinimleri
HDI baskılı devre kartları için malzemelerin geliştirilmesi her zaman "dört yüksek ve bir düşük" gereksinimlerini (yüksek yoğunluk, yüksek frekans, yüksek iletkenlik, yüksek güvenilirlik ve düşük maliyet) karşılamaya odaklanmıştır. Baskılı devre kartlarının artan minyatürleştirme ve performans ihtiyaçları, elektromigrasyona karşı direnç ve boyutsal kararlılık gibi özelliklerin iyileştirilmesiyle karşılanmaktadır.
1.Prepreg (PP) Malzemeler
- Kompozisyon: Reçine + güçlendirilmiş malzemeler (tipik olarak fiberglas)
- Avantajlar 2025:
- Düşük maliyetli
- İyi mekanik sertlik
- Geniş uygulanabilirlik
- Sınırlamalar:
- Orta düzeyde güvenilirlik (daha zayıf CAF direnci)
- Daha düşük ped soyulma mukavemeti (düşme testi gerektiren uygulamalar için uygun değildir)
- Tipik Uygulamalar: Orta-alt seviye tüketici elektroniği (örn. ekonomik akıllı telefonlar)
2.Reçine Kaplı Bakır (RCC) Malzemeler
- Türleri:
- Metalize PI film
- PI film + yapıştırıcı ile lamine edilmiş bakır folyo (“Saf PI”)
- Dökme PI film (bakır folyo üzerine kürlenmiş sıvı PI)
- Avantajlar 2025:
- Mükemmel üretilebilirlik
- Yüksek güvenilirlik
- Üstün ped soyulma mukavemeti (düşme testi uygulamaları için ideal)
- Etkinleştirilmiş mikrovia lazer delme teknolojisi
- Sınırlamalar:
- Daha yüksek maliyet
- Daha düşük genel sertlik (potansiyel eğrilme sorunları)
- Etki: SMT'den CSP paketlemeye geçişe öncülük etti
3.Lazerle Delinebilir Prepreg (LDP) Malzemeler
- Konumlandırma: PP ve RCC arasında maliyet-performans dengesi
- Avantajlar 2025:
- PP'ye göre daha iyi CAF direnci
- Geliştirilmiş dielektrik katman homojenliği
- Ped soyulma mukavemeti için uluslararası standartları karşılar/aşar
- Uygulamalar: Orta-üst seviye mobil cihazlar ve elektronik cihazlar
4. Sıvı Kristal Polimer (LCP) Malzemeler
- Anahtar Özellikler:
- Ultra düşük dielektrik sabiti (Dk=2,8 @1GHz)
- Minimum kayıp tanjantı (0,0025)
- Doğal alev geciktirici (halojensiz)
- Üstün boyutsal kararlılık
- Avantajlar 2025:
- Yüksek frekanslı/yüksek hızlı tasarımlar için ideal
- Çevre dostu
- Geleneksel PI hakimiyetine meydan okuma
- Uygulamalar: Üst düzey RF/mikrodalga devreleri, gelişmiş paketleme
Malzeme Seçim Kılavuzu
| Malzeme | Maliyet | Güvenilirlik | Yüksek Frekans | Sertlik | İçin En İyisi |
|---|---|---|---|---|---|
| PP | Düşük | Orta düzeyde | No | Yüksek | Ekonomik tüketici cihazları |
| RCC | Yüksek | Mükemmel | Orta düzeyde | Düşük | Hassas uygulamaları bırakarak test edin |
| LDP | Orta | İyi | Sınırlı | Yüksek | Premium mobil cihazlar |
| LCP | Çok Yüksek | Olağanüstü | Evet | Orta | 5G/RF/gelişmiş paketleme |
PCB üretim sürecinde çekirdek içeren kartlar ile çekirdeksiz kartlar arasındaki fark
I.Çekirdek Tabanlı HDI Üretim Süreci
1. Çekirdek Kurul Özellikleri
- Yapısal Tasarım:
- Geçiş delikleri veya hibrit gömülü/kör/geçiş delikli yapılar kullanır (tipik olarak 4-6 katman)
- İsteğe bağlı metal çekirdekli yapı (gelişmiş termal dağılım)
Teknik Parametreler:
| Parametre | Çekirdek Kurul | Biriktirme Katmanları |
|---|---|---|
| Delik çapı | ≥0,2 mm | ≤0,15 mm (mikrovialar) |
| İz/boşluk genişliği | ≥0,08 mm | ≤0,08 mm |
| Ara bağlantı yoğunluğu | Düşük | Ultra yüksek yoğunluk |
2. Temel Kurul İşlevleri
- Mekanik destek (sağlamlık sağlar)
- Birikim katmanları arasında elektriksel ara bağlantı köprüsü
- Termal yönetim (özellikle metal çekirdekli kartlar için)
3. Temel Ön Arıtma Süreçleri
- Tedavi yoluyla: Dolgu + yüzey düzleştirme
- Yüzey işleme: Akımsız bakır kaplama + elektrokaplama (1-3µm kalınlık)
- Desen aktarımı:LDI lazer doğrudan görüntüleme (±5µm hassasiyet)
II. Çığır Açan Çekirdeksiz HDI Teknolojisi
1. Temsili Teknolojiler
- ALIVH (Herhangi Bir Katman Arası Geçiş Deliği)
- B²IT (Gömülü Bump Ara Bağlantı Teknolojisi)
2. Devrim Niteliğinde Avantajlar
| Karşılaştırma | Çekirdek Tabanlı HDI | Çekirdeksiz HDI |
|---|---|---|
| Yapı | Çekirdek + yapı bölgeleri | Homojen katman tasarımı |
| Ara Bağlantı Yoğunluğu | Önemli katman farklılıkları | Tek tip ultra yüksek yoğunluk (çekirdeğe kıyasla +) |
| Sinyal İletimi | Daha uzun yollar (çekirdek kaynaklı gecikme) | Mümkün olan en kısa yollar |
| Kalınlık Kontrolü | Çekirdek ile sınırlı (≥0,4 mm) | 0,2 mm'ye ulaşabilir |
3. Temel Süreç Yenilikleri
- Katman ara bağlantısı:
- Akımsız bakırı iletken macun veya bakır çıkıntılarla değiştirir
- Herhangi bir katman mikrovialar için lazer ablasyonu (≤50µm çap)
- Güvenilirlik güvencesi:
- Nano ölçekli yüzey pürüzlendirme (Ra≤0,5µm)
- Düşük sertlikte dielektrik malzemeler (Tg≥200℃)
Son Sözler
Lazer delme, malzeme bilimi ve çok katmanlı istifleme alanlarındaki ilerlemelerden güç alan HDI PCB'ler, minyatürleştirme ve yüksek performanslı elektroniğin en ileri noktasını temsil etmektedir. Cihazlar daha yüksek hızlar, daha düşük gecikme süresi ve daha yüksek güvenilirlik talep ettikçe HDI teknolojisi gelişmeye devam edecek ve PCB üretiminin sınırlarını zorlayacaktır.










İlgili Yazılar