Hvordan udfører man reflow-lodning på dobbeltsidet printkort?
Indholdsfortegnelse
Hvorfor er dobbeltsidet PCB-reflowlodning en udfordring i elektronikproduktion?
I højtydende elektroniske produkter som f.eks. smartphones og industrielle kontrolenheder, dobbeltsidet PCB design er blevet standard. Dobbeltsidet lodning giver dog to store udfordringer:
- Kompleksitet i varmestyring - Under lodningen på den anden side bliver den første side genopvarmet, hvilket kan medføre, at komponenterne løsner sig, eller at loddefugen svigter.
- Dilemma ved valg af proces - Processerne med loddepasta og rød lim har hver især fordele og ulemper, som kræver nøje overvejelser baseret på komponentlayout.
Kontakt vores procesingeniører til skræddersyede løsninger
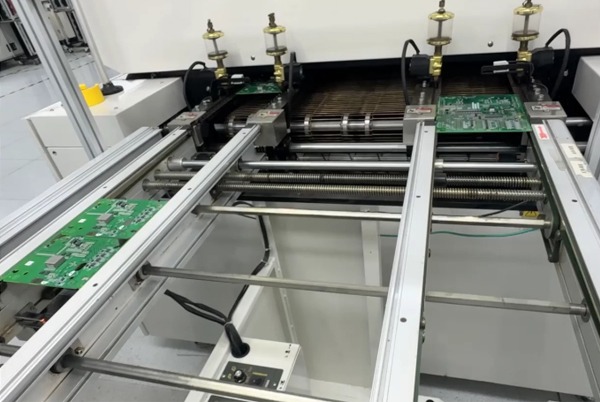
Dybtgående sammenligning af to hovedloddeprocesser
Mulighed A: Dobbeltsidet loddepastaproces (ideel til komponenter med høj densitet)
Bedst til:
- PCB'er med BGA'er, QFN'er eller andre præcisions-IC'er på begge sider
- Letvægtskomponenter generelt
Vigtige skridt:
- Side A: Print loddepasta → Placer komponenter → Reflow-lodning (spidstemperatur 245 °C)
- Afkøl til stuetemperatur, og vend derefter PCB
- Side B: Print loddepasta → Placer komponenter → Brug en trinvis temperaturprofil (reducer spidstemperaturen med 5-10 °C)
Fordele:
- Høj pålidelighed i loddefugen
- Velegnet til automatiseret masseproduktion
Risici:
- Store komponenter kan løsne sig under den anden reflow.
- Præcis temperaturstyring er nødvendig for lodning på den anden side
Mulighed B: Loddepasta + rød lim hybridproces (løsning til store komponenter)
Bedst til:
- Den ene side har store stik/elektrolytiske kondensatorer
- Blandede layouts med betydelige vægtforskelle
Innovativ proces:
- Loddepastasiden (side A): Standard reflow-lodning
- Rød limside (side B): “Print-Place-Cure” tretrinsmetode:
- Tryknøjagtighed for rød lim: ±0,1 mm
- Hærdningstemperatur: 120-150°C (meget lavere end smeltepunktet for loddepasta)
- Valgfri bølgelodning for øget pålidelighed
Tekniske noter:
- Rød lim skal være mindst 0,3 mm væk fra loddepuderne
- Forlæng hærdetiden med 30 % for at forhindre svag vedhæftning
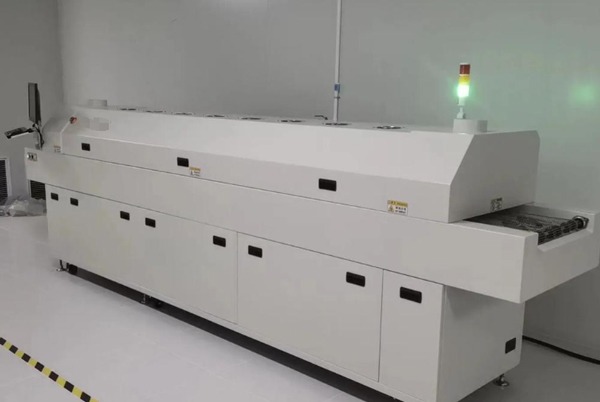
Få gratis ekspertguider til håndværk
5 gyldne regler for kvalitetskontrol af lodning
- Optimer temperaturprofilen
- Første side: Standard Ramp-Soak-Spike (RSS)-kurve (2-3°C/s opvarmningshastighed)
- Anden side:Brug Ramp-to-Spike-kurve (RTS) (forlænget forvarmningstid)
- Retningslinjer for komponentlayout
- Placer tunge komponenter på samme side
- Forskudte dobbeltsidede BGA'er for at undgå termisk spændingskoncentration
- Kriterier for valg af loddepasta
- Anden side: Brug loddepasta til lave temperaturer (f.eks. Sn42/Bi58)
- Rød lims viskositet:>50.000 cps
- Kritiske udstyrsparametre
- Hældning af reflow-ovnens transportbånd: 5-7°.
- Kølehastighed: 4-6°C/s
- Opgraderinger af inspektionsteknologi
- Brug 3D SPI til inspektion af loddepastatykkelse
- Obligatorisk akustisk mikroskopi efter anden reflow
Almindelige problemer og tekniske løsninger
Problem 1: QFN-komponent forskydes under andet reflow
- Løsning: Påfør højtemperaturslim efter lodning på første side
- Parametre:Brug klæbemiddel med >200°C hærdningstolerance
Problem 2: Komponenter falder af under bølgelodning (rød limside)
- Forbedringer:
- Efterhærdning med UV efter påføring af rød lim
- Forvarm til 100°C før bølgelodning
Problem 3: Overdreven hulrum i BGA-samlinger
- Procesoptimering:
- Forlæng optøningstiden for loddepasta til 8 timer
- Brug kvælstofassisteret reflow (O₂ <500ppm)
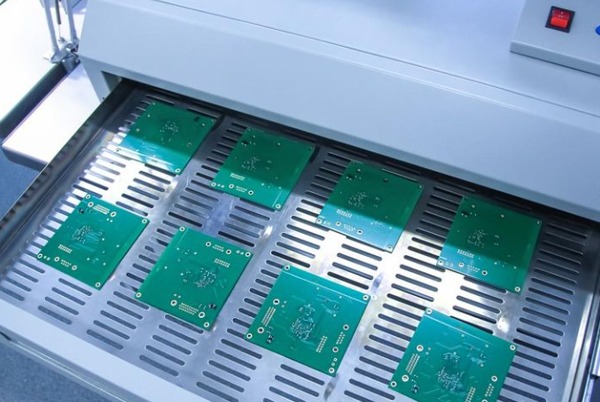
Fremtidige procestendenser
- Lodning ved lav temperatur: Sn-Bi loddelegeringer med pulserende opvarmning
- Smart temperaturkontrol: Maskinlæringsbaseret profiloptimering i realtid
- Hybrid sammenføjning: Kombinerede løsninger med loddepasta + ledende klæbemiddel
Ved systematisk at anvende disse nøgleteknikker kan ingeniører opnå first-pass-udbytter på over 99,5 %.Vi anbefaler at implementere systemer til overvågning af procesvinduer til løbende optimering i produktionsmiljøer.






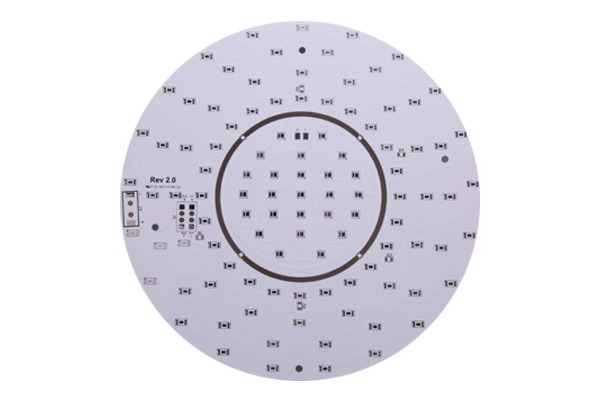



Relaterede indlæg