Placa de circuito impreso de interconexión de alta densidad
Tabla de contenidos
¿Qué es el IDH?
La IDH, que se refiere a una mayor densidad de cableado por unidad de superficie que las placas de circuito impreso convencionales, es una tecnología avanzada. placa de circuito impreso (PCB) que consigue mayores niveles de integración de componentes electrónicos mediante cableado microfino, estructuras de vías microscópicas y cableado denso. Estas placas utilizan cables y huecos más finos (≤ 100 µm/0,10 mm), vías más pequeñas (<150 µm) y almohadillas (20 almohadillas/cm2) que la tecnología de PCB convencional.
Características principales
- Mayor anchura e interlineado: normalmente ≤100 µm (0,10 mm), muy inferior a la de los PCB convencionales (normalmente 150 µm+).
- Minúsculos orificios pasantes:
- Vías incrustadas por láser: <150 µm de diámetro, perforado con láser para conexiones de alta densidad entre capas.
- Agujeros apilados/escalonados: Mejora la utilización del espacio vertical y reduce las necesidades de capas.
- Alta densidad de almohadillas: >20 pads/cm² para admitir chips multipolo (por ejemplo, paquetes BGA, CSP).
- Materiales finos: Utilización de sustratos de baja constante dieléctrica y alta estabilidad (por ejemplo, FR4, poliimida).
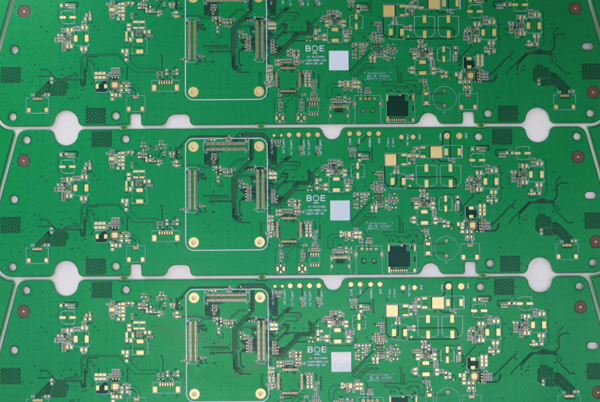
Características principales de las placas HDI (frente a las placas de circuito impreso convencionales)
1. Diseño de microvías (perforación láser dominada)
- Elección de tecnología: Las tarjetas HDI suelen utilizar taladrado láser (diámetros de agujero típicamente ≤150µm) en lugar de la perforación mecánica. Entre las razones se incluyen:
- Límites de perforación mecánica: 0.15mm agujas de perforación son fáciles de romper, tienen altos requisitos de RPM y baja eficiencia, y la incapacidad para realizar el control de profundidad de agujeros ciegos enterrados.
- Ventaja láser: Puede procesar orificios diminutos (por ejemplo, 50µm), admite IDH de cualquier capay no tiene contacto físico y alto rendimiento.
2. Diseños de microvías y anillos perforados Diámetro de la vía ≤150µm
- Vías ≤150µm y vías (pads) ≤250µm, liberando espacio de trazado al estrechar la vía.
- ejemplo: Si el diámetro de la abertura se reduce de 0,30 mm a 0,10 mm (vías láser), el diámetro de la pastilla puede reducirse de 0,60 mm a 0,35 mm, ahorro de espacio 67%.
- Perforación directa de almohadillas (Via-in-Pad): optimiza aún más la disposición de los componentes BGA/SMD y aumenta la densidad.
3. Alta densidad de puntos de soldadura (>130 puntos/p²)
- La densidad de las pastillas de soldadura determina la integración de los componentes. HDI realiza módulo multifuncional ensamblaje de alta densidad (por ejemplo, placas base de teléfonos móviles) a través de agujeros/cables micro-miniatura.
4. Alta densidad de cableado (>117 hilos/pulg²)
- Para adaptarse al aumento de componentes, es necesario aumentar simultáneamente la densidad de líneas. HDI consigue un cableado complejo mediante cableado fino (anchura/espacio entre líneas ≤100µm) y apilamiento multicapa.
5. Línea fina (ancho de línea/espacio ≤ 3 mil/75µm)
- Norma teórica75µm/75µm, pero en la práctica se suele utilizar 100µm/100µm. Razón:
- Coste del procesoEl proceso de 75 µm es exigente en cuanto a equipos/materiales, bajo rendimiento, pocos proveedores y alto coste.
- Equilibrio entre precio y prestaciones: La solución de 100 µm logra un equilibrio entre densidad y coste y es adecuada para la mayoría de las necesidades de la electrónica de consumo.
Principales ventajas de IDH
| Dimensión | Consejo de IDH | PCB tradicional |
|---|---|---|
| Tecnología de perforación | Taladrado láser (agujeros ciegos enterrados, capas arbitrarias) | Perforación mecánica (basada en orificios pasantes) |
| Diámetro del orificio/Anillo del orificio | ≤150µm/≤250µm | ≥200µm/≥400µm |
| Densidad de cableado | >117 hilos/pulg². | <50 hilos/pulg². |
| Anchura/Paso del alambre | ≤100µm (Corriente principal) | ≥150µm |
HDI promueve la miniaturización y el alto rendimiento de los productos electrónicos mediante microvía, línea fina e interconexiones de alta densidady es una tecnología clave para el 5G, la IA y los dispositivos portátiles.

HDI PCB Hoja de especificaciones técnicas
| Característica | HDI PCB Especificaciones técnicas |
|---|---|
| Las capas | Estándar: 4-22 capas Avanzado: Hasta 30 capas |
| Aspectos más destacados | - Mayor densidad de almohadillas - Rastro/espacio más fino (≤75µm) - Microvías (ciegas/enterradas, interconexión de cualquier capa) - Diseño Via-in-Pad |
| Creación de IDH | 1+N+1, 2+N+2, 3+N+3, 4+N+4, Cualquier capa (ELIC), Ultra HDI (I+D) |
| Materiales | FR4 (estándar/alto rendimiento), FR4 sin halógenos, Rogers (para aplicaciones de alta frecuencia) |
| Peso del cobre (acabado) | 18μm - 70μm |
| Min. Traza/Espacio | 0,075mm / 0,075mm (75µm/75µm) |
| Espesor de PCB | 0,40 mm - 3,20 mm |
| Max. Tamaño del tablero | 610 mm × 450 mm (limitado por la capacidad de perforación láser) |
| Acabado superficial | OSP, ENIG, Estaño de inmersión, Plata de inmersión, Oro electrolítico, Dedos de oro |
| Mín. Tamaño del agujero | Perforación mecánica: 0,15 mm Taladrado láser: - Estándar: 0,10 mm (100 µm) - Avanzado: 0,075 mm (75 µm) |
Aplicaciones y principales ventajas de las tarjetas de IDH
I. Principales ámbitos de aplicación de las tarjetas de IDH
Con el avance de la tecnología de semiconductores hacia la miniaturización y el alto rendimiento, la tecnología HDI se ha convertido en un habilitador crítico para la electrónica moderna, dominando especialmente los siguientes campos:
- Comunicaciones móviles
- Teléfonos inteligentes (4G/5G): El enrutamiento de alta densidad admite módulos multicámara, antenas 5G y procesadores de alta velocidad (por ejemplo, chips empaquetados en BGA).
- Equipo de estación base: La transmisión de señales de alta frecuencia (por ejemplo, bandas de ondas milimétricas) depende de los materiales de baja pérdida de HDI (por ejemplo, Rogers).
- Electrónica de consumo
- Dispositivos portátiles: Los diseños ultrafinos (por ejemplo, placas base de smartphones plegables, auriculares TWS) requieren el apilamiento de capas finas de HDI (estructura 1+N+1).
- Cámaras digitales/AR/VR: Los sensores de alta resolución y los módulos miniaturizados dependen de las microvías (<75µm) y de la tecnología Via-in-Pad.
- Electrónica automotriz
- Sistemas avanzados de asistencia al conductor (ADAS): Los radares y los sistemas de infoentretenimiento exigen la alta fiabilidad de los HDI (resistencia al calor y a las vibraciones).
- Informática de alto rendimiento
- Servidores/GPU de IA: La alta conductividad y el diseño térmico favorecen la transmisión de altas corrientes (grosor del cobre ≥70µm).
II. Las ventajas "cuatro altas y una baja" de la tecnología IDH
| Ventaja | Aplicación técnica | Valor de la aplicación |
|---|---|---|
| Enrutamiento de alta densidad | Traza/espacio ≤75µm, microvías (perforación láser) | Reduce el área de la placa de circuito impreso en >30%, reduciendo el tamaño del producto final |
| Alta frecuencia y alta velocidad | Materiales de baja densidad (por ejemplo, PTFE), control de impedancia (±5%) | Admite integridad de señal 5G/6G mmWave y SerDes de alta velocidad |
| Alta conductividad | Interconexión de cualquier capa (ELIC), tecnología de chapado via-filling | Reduce el retardo de la señal entre capas y mejora la velocidad de transmisión de datos. |
| Alta fiabilidad de aislamiento | Sustratos sin halógenos, laminación de precisión (índice de expansión ≤3%). | Cumple la certificación de automoción AEC-Q200, prolonga la vida útil 50% |
| Bajo coste | Menos capas (por ejemplo, sustitución de placas de circuito impreso de 8 capas con orificios pasantes por HDI de 4 capas), perforación láser automatizada (rendimiento >98%) | Reduce el coste total en 15%-20% |
III. Perspectivas del mercado y datos complementarios
- Tendencia de crecimiento: Entre 2000 y 2008, la producción mundial de placas de IDH creció a una TCAC de >14% (datos de Prismark). En 2023, el tamaño del mercado superaba los 1.400 millones de toneladas, con una CAGR prevista para 2030 de 8,31 toneladas.
- Evolución tecnológica: La tecnología Ultra HDI (traza/espacio ≤40µm) y de componentes integrados impulsará aún más el desarrollo de la AIoT y los dispositivos wearables.
Con sus características de "cuatro altos y un bajo", la tecnología HDI es uno de los principales impulsores del avance de la industria electrónica y encierra un inmenso potencial para las comunicaciones 6G, los vehículos autónomos y la computación cuántica.
Clasificación de las tarjetas IDH
Las placas HDI se clasifican en tres tipos principales según el método de apilamiento y el número de vías ciegas laminadas:
(1) Tipo 1+N+1
- Estructura: Presenta una única capa de laminación para interconexiones de alta densidad.
- Características:
- La solución de IDH más rentable
- Adecuado para diseños de complejidad moderada
- Aplicaciones típicas: Smartphones básicos, electrónica de consumo
(2) i+N+i (i≥2) Tipo
- Estructura: Incorpora dos o más capas de laminación para interconexiones de alta densidad.
- Características principales:
- Admite configuraciones de microvías escalonadas o apiladas
- Los diseños avanzados suelen utilizar microvías apiladas rellenas de cobre
- Proporciona mayor densidad de enrutamiento e integridad de la señal
- Aplicaciones:
- Dispositivos móviles de gama media-alta
- Equipos de red
- Electrónica del automóvil
(3) Tipo de interconexión de cualquier capa (ELIC)
- Estructura: Todas las capas utilizan interconexiones de alta densidad con microvías apiladas rellenas de cobre.
- Ventajas:
- Permite una total libertad de diseño para las conexiones entre capas
- Solución óptima para componentes con un elevado número de patillas (por ejemplo, CPU, GPU)
- Maximiza el aprovechamiento del espacio en diseños compactos
- Casos de uso típicos:
- Smartphones insignia
- Informática de alto rendimiento
- Dispositivos portátiles avanzados
Comparación técnica
| tipo | Recuento de laminación | A través de la estructura | Factor de coste | Aplicaciones típicas |
|---|---|---|---|---|
| 1+N+1 | Laminado simple | Microvías básicas | Más bajo | Electrónica de consumo básica |
| i+N+i (i≥2) | Laminados múltiples | Microvías apiladas/escalonadas | moderado | Móviles/redes de gama media |
| ELIC | Todas las capas | Vías apiladas rellenas de cobre | Más alto | Informática de gama alta/móvil |
Este sistema de clasificación ayuda a los diseñadores a seleccionar la tecnología IDH adecuada en función de los requisitos de rendimiento, complejidad y coste. La evolución de 1+N+1 a ELIC representa un aumento de las capacidades para soportar aplicaciones electrónicas más avanzadas.
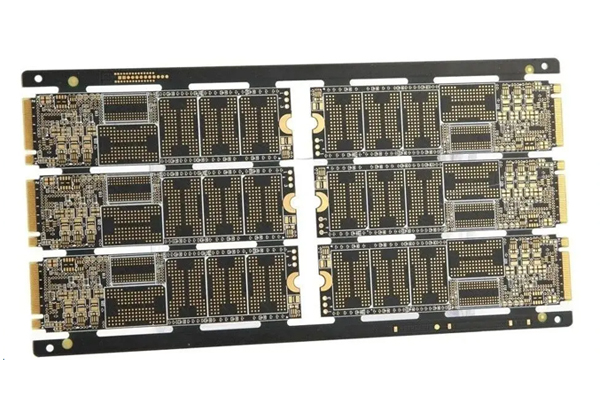
Requisitos de rendimiento de los materiales de las placas de circuito impreso HDI/BUM
El desarrollo de materiales para placas de circuitos impresos de IDH siempre se ha centrado en cumplir los requisitos de "cuatro altos y un bajo" (alta densidad, alta frecuencia, alta conductividad, alta fiabilidad y bajo coste). Las crecientes necesidades de miniaturización y rendimiento de las placas de circuitos impresos se satisfacen mejorando propiedades como la resistencia a la electromigración y la estabilidad dimensional.
1. Materiales preimpregnados (PP)
- Composición: Resina + materiales reforzados (normalmente fibra de vidrio)
- Ventajas:
- Bajo coste
- Buena rigidez mecánica
- Amplia aplicabilidad
- Limitaciones:
- Fiabilidad moderada (resistencia CAF más débil)
- Menor resistencia al pelado de la almohadilla (no apta para aplicaciones exigentes de ensayo de caída)
- Aplicaciones típicas: Electrónica de consumo de gama media-baja (por ejemplo, smartphones económicos)
2. Materiales de cobre revestido de resina (RCC)
- Tipos:
- Película PI metalizada
- Película PI + lámina de cobre laminada con adhesivo ("PI puro")
- Película PI fundida (PI líquido curado sobre lámina de cobre)
- Ventajas:
- Excelente fabricabilidad
- Alta fiabilidad
- Resistencia superior al pelado de la almohadilla (ideal para aplicaciones de pruebas de caída)
- Tecnología de perforación láser microvia habilitada
- Limitaciones:
- Mayor coste
- Menor rigidez general (posibles problemas de alabeo)
- Impacto: Pionera en la transición del embalaje SMT al CSP
3. Materiales preimpregnados perforables por láser (LDP)
- Posicionamiento: Equilibrio coste-rendimiento entre PP y CCR
- Ventajas:
- Mejor resistencia al CAF que el PP
- Mejora de la uniformidad de la capa dieléctrica
- Cumple o supera las normas internacionales de resistencia al pelado de las almohadillas
- Aplicaciones: Dispositivos móviles y electrónica de gama media-alta
4. Materiales de polímero de cristal líquido (LCP)
- Propiedades clave:
- Constante dieléctrica ultrabaja (Dk=2,8 @1GHz)
- Mínima pérdida tangente (0,0025)
- Ignifugación inherente (sin halógenos)
- Estabilidad dimensional superior
- Ventajas:
- Ideal para diseños de alta frecuencia/alta velocidad
- Respetuoso con el medio ambiente
- Desafiar el dominio tradicional de la IP
- Aplicaciones: Circuitos RF/microondas de gama alta, envasado avanzado
Guía de selección de materiales
| Material | costo | Fiabilidad | Alta frecuencia | Rigidez | Lo mejor para |
|---|---|---|---|---|---|
| PP | baja | moderado | No | alto | Dispositivos de consumo económicos |
| CCR | alto | Excelente | moderado | baja | Aplicaciones sensibles a las caídas |
| PLD | Medio | bueno | Limitado | alto | Dispositivos móviles premium |
| LCP | Muy alta | Excepcional | Sí | Medio | 5G/RF/empaquetado avanzado |
Diferencia en el proceso de fabricación de placas de circuito impreso entre placas con núcleo y placas sin núcleo
I. Proceso de fabricación de IDH basado en el núcleo
1. Características de la placa base
- Diseño estructural:
- Utiliza agujeros pasantes o estructuras híbridas enterradas/ciegas/de agujeros pasantes (normalmente de 4 a 6 capas).
- Construcción opcional con núcleo metálico (disipación térmica mejorada)
Parámetros técnicos:
| Parámetro | Consejo central | Capas de acumulación |
|---|---|---|
| Diámetro del orificio pasante | ≥0,2 mm | ≤0,15 mm (microvías) |
| Anchura de huella/espacio | ≥0,08 mm | ≤0,08 mm |
| Densidad de interconexión | baja | Densidad ultra alta |
2. Funciones básicas del Consejo
- Soporte mecánico (garantiza la rigidez)
- Puente de interconexión eléctrica entre las capas de acumulación
- Gestión térmica (especialmente para placas con núcleo metálico)
3. Procesos clave de pretratamiento
- Mediante tratamiento: Relleno de la vía + planarización de la superficie
- Tratamiento de superficies: Cobreado químico + galvanoplastia (espesor 1-3µm)
- Transferencia de patrones: Imágenes directas por láser LDI (precisión de ±5µm)
II. Innovadora tecnología de IDH sin núcleo
1. Tecnologías representativas
- ALIVH (Cualquier capa Interstitial Via Hole)
- B²IT (Tecnología de interconexión de baches enterrados)
2. Ventajas revolucionarias
| Comparación | IDH basado en núcleo | IDH sin núcleo |
|---|---|---|
| Estructura | Núcleo + zonas de acumulación | Diseño de capas homogéneas |
| Densidad de interconexión | Variación significativa de la capa | Densidad ultraelevada uniforme (+40% frente al núcleo) |
| Transmisión de señales | Trayectos más largos (retraso inducido por el núcleo) | Caminos más cortos posibles |
| Control del espesor | Limitado por el núcleo (≥0,4 mm) | Puede alcanzar <0,2 mm |
3. Innovaciones en los procesos básicos
- Interconexión de capas:
- Sustituye el cobre químico por pasta conductora o pletinas de cobre
- Ablación láser para microvías de cualquier capa (≤50µm de diámetro)
- Garantía de fiabilidad:
- Rugosidad superficial a nanoescala (Ra≤0,5µm)
- Materiales dieléctricos de bajo curado (Tg≥200℃)
Observaciones finales
Impulsados por los avances en perforación láser, ciencia de los materiales y apilamiento multicapa, los PCB HDI representan la vanguardia de la miniaturización y la electrónica de alto rendimiento. La tecnología HDI seguirá evolucionando a medida que los dispositivos exijan mayores velocidades, menor latencia y mayor fiabilidad, lo que ampliará los límites de la fabricación de placas de circuito impreso.










Entradas relacionadas